
Мощный МОП-транзистор — это особый тип полевого транзистора металл-оксид-полупроводник (МОП-транзистор), предназначенный для работы со значительными уровнями мощности. По сравнению с другими силовыми полупроводниковыми приборами , такими как биполярный транзистор с изолированным затвором (IGBT) или тиристор , его основными преимуществами являются высокая скорость переключения и хорошая эффективность при низких напряжениях. Он разделяет с IGBT изолированный затвор, что упрощает управление. Они могут иметь низкий коэффициент усиления, иногда до такой степени, что напряжение затвора должно быть выше контролируемого напряжения.
Разработка силовых МОП-транзисторов стала возможной благодаря развитию технологий МОП-транзисторов и КМОП , используемых для производства интегральных схем с 1960-х годов. Силовой МОП-транзистор разделяет принцип работы с маломощным аналогом, латеральным МОП-транзистором. Силовой МОП-транзистор, который обычно используется в силовой электронике , был адаптирован из стандартного МОП-транзистора и представлен коммерчески в 1970-х годах. [2]
Мощный МОП-транзистор является наиболее распространенным силовым полупроводниковым прибором в мире благодаря своей низкой мощности управления затвором, высокой скорости переключения, [3] простой возможности параллельного соединения, [3] [4] широкой полосе пропускания, прочности, простоте управления, простоте смещения, простоте применения и простоте ремонта. [4] В частности, это наиболее широко используемый низковольтный (менее 200 В) переключатель. Его можно найти в широком спектре приложений, таких как большинство источников питания , преобразователи постоянного тока в постоянный , низковольтные контроллеры двигателей и многие другие приложения.
MOSFET был изобретен в Bell Labs между 1955 и 1960 годами. [5] [6] [7] [8] [9] Это был прорыв в силовой электронике . Поколения MOSFET позволили разработчикам электроники достичь уровней производительности и плотности, которые невозможны с биполярными транзисторами. [10]
В 1969 году Hitachi представила первый вертикальный силовой МОП-транзистор, [11] который позже стал известен как VMOS (V-образный МОП-транзистор). [12] В том же году DMOS (двойной диффузионный МОП-транзистор) с самосовмещенным затвором был впервые представлен Y. Tarui, Y. Hayashi и Toshihiro Sekigawa из Электротехнической лаборатории (ETL). [13] [14] В 1974 году Jun-ichi Nishizawa из Университета Тохоку изобрел мощный МОП-транзистор для аудио, который вскоре был произведен Yamaha Corporation для своих высококачественных аудиоусилителей . JVC , Pioneer Corporation , Sony и Toshiba также начали производство усилителей с мощными МОП-транзисторами в 1974 году. [ 15] Siliconix представила VMOS на коммерческой основе в 1975 году. [12]
VMOS и DMOS развились в то, что стало известно как VDMOS (вертикальный DMOS). [15] Исследовательская группа Джона Молла в HP Labs изготовила прототипы DMOS в 1977 году и продемонстрировала преимущества по сравнению с VMOS, включая более низкое сопротивление в открытом состоянии и более высокое напряжение пробоя. [12] В том же году Hitachi представила LDMOS (боковой DMOS), планарный тип DMOS. Hitachi была единственным производителем LDMOS в период с 1977 по 1983 год, в течение которого LDMOS использовались в аудиоусилителях мощности таких производителей, как HH Electronics (серия V) и Ashly Audio , и использовались для музыкальных и публичных систем оповещения . [15] С появлением цифровой мобильной сети 2G в 1995 году LDMOS стал наиболее широко используемым усилителем мощности ВЧ в мобильных сетях, таких как 2G, 3G , [16] и 4G . [17]
Алекс Лидов был соавтором изобретения HexFET, гексагонального типа силового МОП-транзистора, в Стэнфордском университете в 1977 году [18] вместе с Томом Германом. [19] HexFET был выпущен в продажу компанией International Rectifier в 1978 году. [12] [19] Биполярный транзистор с изолированным затвором ( IGBT), который сочетает в себе элементы как силового МОП-транзистора, так и биполярного транзистора с переходом (BJT), был разработан Джайантом Балигой в General Electric в период с 1977 по 1979 год. [20]
МОП-транзистор superjunction — это тип мощного МОП-транзистора, который использует столбцы P+, проникающие в эпитаксиальный слой N−. Идея наложения слоев P и N была впервые предложена Шозо Сирота и Шигео Канедой в Университете Осаки в 1978 году . [21] Дэвид Дж. Ко из Philips изобрел МОП-транзистор superjunction с чередующимися слоями p-типа и n-типа, подав заявку на патент США в 1984 году, который был выдан в 1988 году. [22]


Мощный МОП-транзистор является наиболее широко используемым силовым полупроводниковым прибором в мире. [3] По состоянию на 2010 год [обновлять]на силовой МОП-транзистор приходится 53% рынка силовых транзисторов , опережая биполярные транзисторы с изолированным затвором (27%), усилители мощности ВЧ (11%) и биполярные транзисторы с переходом (9%). [23] По состоянию на 2018 год [обновлять]ежегодно поставляется более 50 миллиардов силовых МОП-транзисторов. [24] К ним относятся силовой МОП-транзистор Trench, проданный тиражом более 100 миллиардов единиц по состоянию на февраль 2017 года, [25] и MDmesh (суперпереходный МОП-транзистор) от STMicroelectronics , проданный тиражом 5 миллиардов единиц по состоянию на 2019 год [обновлять]. [21]
Мощные МОП-транзисторы широко используются в широком спектре бытовой электроники . [26] [27]
RF DMOS, также известный как RF power MOSFET, представляет собой тип DMOS power транзистора, разработанный для радиочастотных (РЧ) приложений. Он используется в различных радио- и РЧ приложениях. [28] [29]
Силовые МОП-транзисторы широко используются в транспортной технике, [30] [31] [32] , которая включает в себя широкий спектр транспортных средств .
В автомобильной промышленности [ 33] [34] [35] мощные МОП-транзисторы широко используются в автомобильной электронике . [36] [37] [26]
Мощные МОП-транзисторы (включая DMOS, LDMOS и VMOS ) обычно используются для широкого спектра других применений.

Несколько структур были исследованы в 1970-х годах, когда были представлены первые коммерческие силовые МОП-транзисторы. Однако большинство из них были заброшены (по крайней мере, до недавнего времени) в пользу структуры Vertical Diffused MOS ( VDMOS ) (также называемой Double-Diffused MOS или просто DMOS ) и структуры LDMOS (боково-диффузионная МОП).
Поперечное сечение VDMOS (см. рисунок 1) показывает «вертикальность» устройства: можно увидеть, что электрод истока расположен над стоком, что приводит к току, в основном вертикальному, когда транзистор находится в открытом состоянии. « Диффузия » в VDMOS относится к производственному процессу: P-карманы (см. рисунок 1) получаются в результате процесса диффузии (на самом деле, процесса двойной диффузии для получения областей P и N + , отсюда и название «двойная диффузия»).
Силовые МОП-транзисторы имеют структуру, отличную от латерального МОП-транзистора: как и большинство силовых устройств, их структура вертикальная, а не планарная. В планарной структуре номиналы тока и пробивного напряжения являются функциями размеров канала (соответственно ширины и длины канала), что приводит к неэффективному использованию «кремниевой недвижимости». При вертикальной структуре номинал напряжения транзистора является функцией легирования и толщины эпитаксиального слоя N (см. поперечное сечение), в то время как номинал тока является функцией ширины канала. Это позволяет транзистору выдерживать как высокое блокирующее напряжение, так и высокий ток в компактном куске кремния.
LDMOS — это мощные МОП-транзисторы с боковой структурой. Они в основном используются в высококачественных усилителях мощности звука [15] и усилителях мощности ВЧ в беспроводных сотовых сетях , таких как 2G , 3G [16] и 4G . [ 17] Их преимущество заключается в лучшем поведении в области насыщения (соответствующей линейной области биполярного транзистора ) по сравнению с вертикальными МОП-транзисторами. Вертикальные МОП-транзисторы предназначены для коммутационных приложений, поэтому они используются только в состояниях Вкл или Выкл.

Когда силовой МОП-транзистор находится в открытом состоянии (см. МОП-транзистор для обсуждения режимов работы), он демонстрирует резистивное поведение между выводами стока и истока. На рисунке 2 можно увидеть, что это сопротивление (называемое R DSon для "сопротивление стока к истоку в открытом состоянии") является суммой многих элементарных вкладов:

В выключенном состоянии мощный МОП-транзистор эквивалентен PIN-диоду (состоящему из диффузии P + , эпитаксиального слоя N − и подложки N + ). Когда эта крайне несимметричная структура смещена в обратном направлении, область пространственного заряда простирается в основном на слаболегированной стороне, т. е . над слоем N − . Это означает, что этот слой должен выдерживать большую часть напряжения сток-исток МОП-транзистора в выключенном состоянии.
Однако, когда MOSFET находится в состоянии ВКЛ, этот слой N − не имеет функции. Кроме того, поскольку это слаболегированная область, ее собственное сопротивление не является пренебрежимо малым и добавляется к сопротивлению сток-исток MOSFET в состоянии ВКЛ (R DSon ) (это сопротивление R n на рисунке 2).
Два основных параметра определяют как напряжение пробоя, так и R DSon транзистора: уровень легирования и толщина эпитаксиального слоя N − . Чем толще слой и ниже уровень легирования, тем выше напряжение пробоя. Напротив, чем тоньше слой и выше уровень легирования, тем ниже R DSon (и, следовательно, ниже потери проводимости МОП-транзистора). Таким образом, можно видеть, что в конструкции МОП-транзистора существует компромисс между его номинальным напряжением и сопротивлением в открытом состоянии. [ необходима цитата ] Это демонстрирует график на рисунке 3.
На рисунке 1 видно, что металлизация истока соединяет как имплантацию N +, так и имплантацию P + , хотя принцип работы MOSFET требует, чтобы источник был подключен только к зоне N + . Однако, если бы это было так, это привело бы к образованию плавающей зоны P между легированным N источником и стоком, что эквивалентно NPN-транзистору с неподключенной базой. При определенных условиях (при высоком токе стока, когда напряжение стока в открытом состоянии составляет порядка нескольких вольт) этот паразитный NPN-транзистор срабатывает, делая MOSFET неуправляемым. Соединение имплантации P с металлизацией истока замыкает базу паразитного транзистора на его эмиттер (исток MOSFET) и, таким образом, предотвращает ложное защелкивание. Однако это решение создает диод между стоком (катодом) и истоком (анодом) MOSFET, что позволяет ему блокировать ток только в одном направлении.
Встроенные диоды могут использоваться в качестве обратных диодов для индуктивных нагрузок в таких конфигурациях, как мост H или полумост. Хотя эти диоды обычно имеют довольно высокое прямое падение напряжения, они могут выдерживать большие токи и достаточны во многих приложениях, уменьшая количество деталей и, таким образом, стоимость устройства и пространство на плате. Для повышения эффективности часто используется синхронное выпрямление , чтобы минимизировать время, в течение которого встроенный диод проводит ток.

Благодаря своей униполярной природе силовой МОП-транзистор может переключаться с очень высокой скоростью. Действительно, нет необходимости удалять неосновные носители, как в случае с биполярными устройствами. Единственное внутреннее ограничение скорости коммутации обусловлено внутренними емкостями МОП-транзистора (см. рисунок 4). Эти емкости должны заряжаться или разряжаться при переключении транзистора. Это может быть относительно медленным процессом, поскольку ток, протекающий через емкости затвора, ограничен внешней схемой драйвера. Эта схема фактически будет определять скорость коммутации транзистора (при условии, что силовая схема имеет достаточно низкую индуктивность).
В технических описаниях MOSFET емкости часто обозначаются как C iss (входная емкость, сток и исток закорочены), C oss (выходная емкость, затвор и исток закорочены) и C rss (обратная передаточная емкость, источник подключен к земле). Соотношение между этими емкостями и емкостями, описанными ниже, следующее:
Где C GS , C GD и C DS — соответственно емкости затвор-исток, затвор-сток и сток-исток (см. ниже). Производители предпочитают указывать C iss , C oss и C rss , поскольку их можно измерить непосредственно на транзисторе. Однако, поскольку C GS , C GD и C DS ближе к физическому значению, они будут использоваться в оставшейся части статьи.
Емкость C GS образована параллельным соединением C oxN+ , C oxP и C oxm (см. рисунок 4). Поскольку области N + и P сильно легированы, две первые емкости можно считать постоянными. C oxm — это емкость между затвором (поликремния) и электродом истока (металла), поэтому она также постоянна. Поэтому принято считать C GS постоянной емкостью, т. е. ее значение не зависит от состояния транзистора.
Емкость C GD можно рассматривать как последовательное соединение двух элементарных емкостей. Первая из них — это оксидная емкость (C oxD ), образованная затворным электродом, диоксидом кремния и верхней частью эпитаксиального слоя N. Она имеет постоянное значение. Вторая емкость (C GDj ) вызвана расширением зоны пространственного заряда , когда МОП-транзистор находится в выключенном состоянии. Поэтому она зависит от напряжения сток-затвор. Из этого значение C GD равно:
Ширина области пространственного заряда определяется выражением [38]
где - диэлектрическая проницаемость кремния, q - заряд электрона , а N - уровень легирования . Значение C GDj можно аппроксимировать с помощью выражения плоского конденсатора :
Где A GD — площадь поверхности перекрытия затвор-сток. Следовательно, получается:
Видно, что C GDj (и, следовательно, C GD ) — это емкость, значение которой зависит от напряжения затвор-сток. По мере увеличения этого напряжения емкость уменьшается. Когда MOSFET находится в открытом состоянии, C GDj шунтируется, поэтому емкость затвор-сток остается равной C oxD , постоянному значению.
Поскольку металлизация истока перекрывает P-карманы (см. рисунок 1), выводы стока и истока разделены PN-переходом . Следовательно, C DS — это емкость перехода. Это нелинейная емкость, и ее значение можно рассчитать с помощью того же уравнения, что и для C GDj .

Для работы МОП-транзистор должен быть подключен к внешней цепи, в большинстве случаев с использованием проволочного соединения (хотя изучаются и альтернативные методы). Эти соединения демонстрируют паразитную индуктивность, которая никоим образом не является специфической для технологии МОП-транзисторов, но имеет важные эффекты из-за высоких скоростей коммутации. Паразитные индуктивности имеют тенденцию поддерживать свой ток постоянным и генерировать перенапряжение во время выключения транзистора, что приводит к увеличению потерь коммутации.
Паразитная индуктивность может быть связана с каждым выводом МОП-транзистора. Они имеют различные эффекты:
Оксид затвора очень тонкий (100 нм или меньше), поэтому он может выдерживать только ограниченное напряжение. В технических описаниях производители часто указывают максимальное напряжение затвор-исток около 20 В, и превышение этого предела может привести к разрушению компонента. Кроме того, высокое напряжение затвор-исток значительно сокращает срок службы МОП-транзистора, практически не давая преимуществ в снижении R DSon .
Для решения этой проблемы часто используют схему драйвера затвора .
Силовые МОП-транзисторы имеют максимальное заданное напряжение стока-источника (в выключенном состоянии), за пределами которого может произойти пробой . Превышение напряжения пробоя приводит к тому, что устройство проводит ток, что может привести к его повреждению и повреждению других элементов схемы из-за чрезмерного рассеивания мощности.
Ток стока обычно должен оставаться ниже определенного заданного значения (максимальный непрерывный ток стока). Он может достигать более высоких значений в течение очень коротких промежутков времени (максимальный импульсный ток стока, иногда указывается для различных длительностей импульса). Ток стока ограничивается нагревом из-за резистивных потерь во внутренних компонентах, таких как соединительные провода , и другими явлениями, такими как электромиграция в металлическом слое.
Температура перехода (T J ) MOSFET должна оставаться ниже указанного максимального значения для надежной работы устройства, определяемого компоновкой кристалла MOSFET и упаковочными материалами. Упаковка часто ограничивает максимальную температуру перехода из-за характеристик формовочного компаунда и (где используется) эпоксидной смолы.
Максимальная рабочая температура окружающей среды определяется рассеиваемой мощностью и тепловым сопротивлением . Тепловое сопротивление перехода к корпусу является внутренним для устройства и корпуса; тепловое сопротивление корпуса к окружающей среде в значительной степени зависит от схемы платы/монтажа, площади теплоотвода и потока воздуха/жидкости.
Тип рассеивания мощности, непрерывный или импульсный, влияет на максимальную рабочую температуру из-за характеристик тепловой массы ; в общем, чем ниже частота импульсов для заданного рассеивания мощности, тем выше максимальная рабочая температура окружающей среды из-за предоставления более длительного интервала для охлаждения устройства. Модели, такие как сеть Фостера , могут использоваться для анализа динамики температуры от переходных процессов мощности.
Безопасная рабочая область определяет комбинированные диапазоны тока стока и напряжения стока к истоку, которые силовой МОП-транзистор может выдержать без повреждения. Графически она представлена как область на плоскости, определяемая этими двумя параметрами. Как ток стока, так и напряжение стока к истоку должны оставаться ниже соответствующих им максимальных значений, но их произведение также должно оставаться ниже максимальной рассеиваемой мощности, которую может выдержать устройство. Таким образом, устройство не может работать при максимальном токе и максимальном напряжении одновременно. [39]
Эквивалентная схема для силового МОП-транзистора состоит из одного МОП-транзистора, параллельного паразитному биполярному транзистору. Если биполярный транзистор включается, его нельзя выключить, поскольку затвор не контролирует его. Это явление известно как « защелкивание », которое может привести к разрушению устройства. Биполярный транзистор может быть включен из-за падения напряжения на области тела p-типа. Чтобы избежать защелкивания, тело и исток обычно замыкаются накоротко в корпусе устройства.


Как описано выше, способность мощного MOSFET-транзистора выдерживать ток определяется шириной его затворного канала. Ширина затворного канала — это третье (ось Z) измерение поперечных сечений, изображенных на рисунке.
Чтобы минимизировать стоимость и размер, важно сохранить площадь кристалла транзистора как можно меньше. Поэтому были разработаны оптимизации для увеличения ширины поверхности канала, т. е . увеличения «плотности каналов». Они в основном состоят из создания ячеистых структур, повторяющихся по всей площади кристалла MOSFET. Для этих ячеек было предложено несколько форм, наиболее известной из которых является шестиугольная форма, используемая в устройствах HEXFET компании International Rectifier.
Другой способ увеличить плотность каналов — уменьшить размер элементарной структуры. Это позволяет разместить больше ячеек на заданной площади поверхности и, следовательно, увеличить ширину канала. Однако, по мере уменьшения размера ячейки становится все труднее обеспечить надлежащий контакт каждой ячейки. Чтобы преодолеть это, часто используется структура «полосы» (см. рисунок). Она менее эффективна, чем ячеистая структура эквивалентного разрешения с точки зрения плотности каналов, но может справиться с меньшим шагом. Еще одним преимуществом планарной полосовой структуры является то, что она менее восприимчива к отказам во время лавинного пробоя, при котором паразитный биполярный транзистор включается от достаточного прямого смещения. В ячеистой структуре, если вывод источника любой ячейки плохо контактирует, то становится гораздо более вероятным, что паразитный биполярный транзистор защелкнется во время лавинного пробоя. Из-за этого МОП-транзисторы, использующие планарную полосовую структуру, могут выйти из строя только во время лавинного пробоя из-за экстремального теплового напряжения. [40]
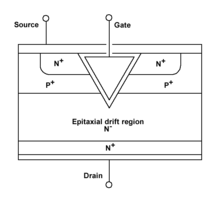

P-субстрат MOSFET (часто называемый PMOS) — это MOSFET с противоположными типами легирования (N вместо P и P вместо N в поперечном сечении на рисунке 1). Этот MOSFET изготовлен с использованием подложки P-типа с эпитаксией P − . Поскольку канал находится в N-области, этот транзистор включается отрицательным напряжением затвор-исток. Это делает его желательным в понижающем преобразователе , где один из выводов переключателя подключен к высокой стороне входного напряжения: с N-MOSFET эта конфигурация требует подачи на затвор напряжения, равного , тогда как с P-MOSFET напряжение более не требуется.
Основным недостатком этого типа MOSFET является плохая производительность в открытом состоянии, поскольку он использует дырки в качестве носителей заряда , которые имеют гораздо более низкую подвижность, чем электроны. Поскольку удельное сопротивление напрямую связано с подвижностью, данное устройство PMOS будет иметь в три раза больше, чем N-MOSFET с теми же размерами.
Структура VMOS имеет V-образную канавку в области затвора и использовалась для первых коммерческих устройств. [41]
В этой структуре мощного МОП-транзистора, также называемой траншейной МОП-транзитором, затворный электрод утоплен в траншее, вытравленной в кремнии. Это приводит к образованию вертикального канала. Основной интерес структуры заключается в отсутствии эффекта JFET. Название структуры происходит от U-образной формы траншеи.
Специально для напряжений свыше 500 В некоторые производители, включая Infineon Technologies с ее продукцией CoolMOS, начали использовать принцип компенсации заряда. С помощью этой технологии сопротивление эпитаксиального слоя, который вносит наибольший вклад (более 95%) в сопротивление устройства высоковольтных МОП-транзисторов, может быть уменьшено более чем в 5 раз.
Стремясь повысить эффективность производства и надежность суперпереходных МОП-транзисторов, компания Renesas Electronics разработала суперпереходную структуру с технологией глубокой канавки. Эта технология подразумевает травление канавок в низкопримесном материале N-типа для формирования областей P-типа. Этот процесс преодолевает проблемы, присущие подходу многоуровневого эпитаксиального роста, и приводит к чрезвычайно низкому сопротивлению в открытом состоянии и уменьшенной внутренней емкости.
Благодаря увеличенной площади pn-перехода структура суперперехода имеет меньшее время обратного восстановления, но больший ток обратного восстановления по сравнению с обычным планарным силовым МОП-транзистором.