Дифракция быстрых электронов на отражение ( ДБЭО ) — это метод , используемый для определения характеристик поверхности кристаллических материалов. Системы RHEED собирают информацию только из поверхностного слоя образца, что отличает RHEED от других методов определения характеристик материалов , которые также основаны на дифракции электронов высоких энергий . Просвечивающая электронная микроскопия , еще один распространенный метод дифракции электронов , отбирает в основном большую часть образца из-за геометрии системы, хотя в особых случаях он может предоставить информацию о поверхности. Дифракция низкоэнергетических электронов (LEED) также чувствительна к поверхности, но LEED обеспечивает поверхностную чувствительность за счет использования электронов низкой энергии.
Для системы RHEED требуется источник электронов (пистолет), экран фотолюминесцентного детектора и образец с чистой поверхностью, хотя современные системы RHEED имеют дополнительные детали для оптимизации метода. [1] [2] Электронная пушка генерирует пучок электронов, которые поражают образец под очень малым углом относительно поверхности образца. Падающие электроны дифрагируют от атомов на поверхности образца, а небольшая часть дифрагированных электронов конструктивно интерферирует под определенными углами и образует регулярные узоры на детекторе. Электроны интерферируют в зависимости от положения атомов на поверхности образца, поэтому картина дифракции на детекторе является функцией поверхности образца. На рисунке 1 показана самая базовая настройка системы RHEED.
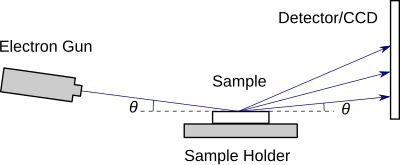
В установке RHEED в картину RHEED вносят вклад только атомы на поверхности образца. [3] Угол скольжения падающих электронов позволяет им покинуть объем образца и достичь детектора. Атомы на поверхности образца дифрагируют (рассеивают) падающие электроны из-за волнообразных свойств электронов.
Дифрагированные электроны конструктивно интерферируют под определенными углами в зависимости от кристаллической структуры и расстояния между атомами на поверхности образца, а также длины волны падающих электронов. Некоторые электронные волны, созданные в результате конструктивной интерференции, сталкиваются с детектором, создавая специфические дифракционные картины в соответствии с особенностями поверхности образца. Пользователи характеризуют кристаллографию поверхности образца посредством анализа дифракционных картин. На рисунке 2 показана схема RHEED. На видео 1 изображен метрологический прибор, записывающий колебания интенсивности RHEED и скорости осаждения для контроля процесса и анализа.

Два типа дифракции способствуют формированию картины RHEED. Некоторые падающие электроны подвергаются однократному упругому рассеянию на поверхности кристалла - процессу, называемому кинематическим рассеянием. [1] Динамическое рассеяние происходит, когда электроны подвергаются многократной дифракции в кристалле и теряют часть своей энергии из-за взаимодействия с образцом. [1] Пользователи извлекают некачественные данные из кинематически дифрагированных электронов. Эти электроны отвечают за пятна или кольца высокой интенсивности, характерные для моделей RHEED. Пользователи RHEED также анализируют динамически рассеянные электроны с помощью сложных методов и моделей для сбора количественной информации из моделей RHEED. [3]
Пользователи RHEED конструируют сферы Эвальда , чтобы определить кристаллографические свойства поверхности образца. Сферы Эвальда показывают разрешенные условия дифракции для кинематически рассеянных электронов в данной установке RHEED. Дифракционная картина на экране соответствует геометрии сферы Эвальда, поэтому пользователи ДБЭД могут напрямую рассчитать обратную решетку образца с картиной ДБЭД, энергию падающих электронов и расстояние от детектора до образца. Пользователь должен связать геометрию и расстояние между пятнами идеального рисунка со сферой Эвальда, чтобы определить обратную решетку поверхности образца.
Анализ сферы Эвальда аналогичен анализу объемных кристаллов, однако обратная решетка образца отличается от таковой для трехмерного материала из-за поверхностной чувствительности процесса ДБЭО. Обратные решетки объемных кристаллов состоят из набора точек в трехмерном пространстве. Однако только первые несколько слоев материала способствуют дифракции в ДБЭД, поэтому условия дифракции в измерении, перпендикулярном поверхности образца, отсутствуют. Из-за отсутствия третьего условия дифракции обратная решетка поверхности кристалла представляет собой серию бесконечных стержней, идущих перпендикулярно поверхности образца. [4] Эти стержни возникают в обычных точках двумерной обратной решетки поверхности образца.
Сфера Эвальда центрирована на поверхности образца с радиусом, равным величине волнового вектора падающих электронов:
где λ — длина волны де Бройля электронов .

Условия дифракции выполняются там, где стержни обратной решетки пересекают сферу Эвальда. Следовательно, величина вектора от начала сферы Эвальда до пересечения любых стержней обратной решетки равна величине падающего луча. Это выражается как
(2)
Здесь k hl — волновой вектор упруго дифрагировавших электронов порядка (hl) при любом пересечении стержней обратной решетки со сферой Эвальда
Проекции двух векторов на плоскость поверхности образца различаются вектором обратной решетки G hl ,
(3)
На рис. 3 показано построение сферы Эвальда и приведены примеры векторов G, khl и ki .
Многие из стержней обратной решетки удовлетворяют условиям дифракции, однако система RHEED сконструирована таким образом, что на детектор попадают только низкие порядки дифракции. Диаграмма RHEED на детекторе представляет собой проекцию только k векторов, находящихся в угловом диапазоне, в котором находится детектор. Размер и положение детектора определяют, какие из дифрагированных электронов находятся в угловом диапазоне, достигающем детектора, поэтому геометрию картины ДБЭО можно связать обратно с геометрией обратной решетки поверхности образца с помощью тригонометрических соотношений. и расстояние от образца до детектора.
Векторы k помечены так, что вектор k00, образующий наименьший угол с поверхностью образца, называется лучом 0-го порядка. [3] Луч 0-го порядка также известен как зеркальный луч. Каждое последовательное пересечение стержня и сферы дальше от поверхности образца отмечается как отражение более высокого порядка. Из-за расположения центра сферы Эвальда зеркальный луч образует с подложкой тот же угол, что и падающий электронный луч. Зеркальная точка имеет наибольшую интенсивность на диаграмме RHEED и по соглашению обозначается как точка (00). [3] Остальные точки на схеме RHEED индексируются в соответствии с порядком отражения, в котором они проецируются.
Радиус сферы Эвальда намного больше, чем расстояние между стержнями обратной решетки, поскольку падающий луч имеет очень короткую длину волны из-за его высокоэнергетических электронов. Ряды стержней обратной решетки фактически пересекают сферу Эвальда как приблизительную плоскость, поскольку идентичные ряды параллельных стержней обратной решетки расположены непосредственно перед и позади показанного единственного ряда. [1] На рис. 3 показано поперечное сечение одного ряда стержней обратной решетки, заполняющих условия дифракции. Стержни обратной решетки на рисунке 3 показывают конец этих плоскостей, которые перпендикулярны экрану компьютера на рисунке.
Пересечения этих эффективных плоскостей со сферой Эвальда образуют круги, называемые кругами Лауэ. Паттерн RHEED представляет собой набор точек по периметру концентрических кругов Лауэ вокруг центральной точки. Однако эффекты интерференции между дифрагировавшими электронами по-прежнему приводят к сильной интенсивности в отдельных точках на каждом круге Лауэ. На рис. 4 показано пересечение одной из этих плоскостей со сферой Эвальда.

Азимутальный угол влияет на геометрию и интенсивность диаграмм RHEED. [4] Азимутальный угол — это угол, под которым падающие электроны пересекают упорядоченную кристаллическую решетку на поверхности образца. Большинство систем RHEED оснащены держателем образца, который может вращать кристалл вокруг оси, перпендикулярной поверхности образца. Пользователи RHEED вращают образец, чтобы оптимизировать профили интенсивности узоров. Пользователи обычно индексируют как минимум два скана RHEED под разными углами азимута для надежной характеристики структуры поверхности кристалла. [4] На рис. 5 представлена схематическая диаграмма падающего на образец электронного луча под разными азимутальными углами.

Во время экспериментов RHEED пользователи иногда вращают образец вокруг оси, перпендикулярной поверхности отбора проб, чтобы создать диаграмму RHEED, называемую азимутальным графиком. [4] Вращение образца изменяет интенсивность дифрагированных лучей из-за их зависимости от азимутального угла. [5] Специалисты RHEED характеризуют морфологию пленок, измеряя изменения интенсивности луча и сравнивая эти изменения с теоретическими расчетами, которые могут эффективно моделировать зависимость интенсивности дифрагированных лучей от азимутального угла. [5]
Динамически или неупруго рассеянные электроны также предоставляют несколько типов информации об образце. Яркость или интенсивность в точке детектора зависит от динамического рассеяния, поэтому весь анализ, связанный с интенсивностью, должен учитывать динамическое рассеяние. [1] [3] Некоторые неупруго рассеянные электроны проникают в объем кристалла и удовлетворяют условиям дифракции Брэгга. Эти неупруго рассеянные электроны могут достигать детектора, создавая дифракционные картины Кикучи, которые полезны для расчета условий дифракции. [3] Картины Кикучи характеризуются линиями, соединяющими точки интенсивной дифракции на картине RHEED. На рисунке 6 показан шаблон RHEED с видимыми линиями Кикучи .

Электронная пушка является одним из наиболее важных компонентов системы RHEED. [1] Пистолет ограничивает разрешение и пределы тестирования системы. Вольфрамовые нити являются основным источником электронов для электронной пушки большинства систем RHEED из-за низкой работы выхода вольфрама. В типичной установке вольфрамовая нить является катодом, а анод с положительным смещением оттягивает электроны с кончика вольфрамовой нити. [1]
Величина анодного смещения определяет энергию падающих электронов. Оптимальное анодное смещение зависит от типа желаемой информации. При больших углах падения электроны высокой энергии могут проникнуть через поверхность образца и ухудшить поверхностную чувствительность прибора. [1] Однако размеры зон Лауэ пропорциональны обратному квадрату энергии электронов, что означает, что больше информации записывается на детекторе при более высоких энергиях падающих электронов. [1] Для общей характеристики поверхности электронная пушка работает в диапазоне 10-30 кэВ. [3]
В типичной установке RHEED одно магнитное и одно электрическое поля фокусируют падающий пучок электронов. [1] Отрицательно смещенный электрод Венельта, расположенный между катодной нитью и анодом, создает небольшое электрическое поле, которое фокусирует электроны, когда они проходят через анод. Регулируемая магнитная линза фокусирует электроны на поверхности образца после того, как они проходят через анод. Типичный источник RHEED имеет фокусное расстояние около 50 см. [3] Луч фокусируется в минимально возможной точке детектора, а не на поверхности образца, поэтому дифракционная картина имеет наилучшее разрешение. [1]
В качестве детекторов широко используются фосфорные экраны, проявляющие фотолюминесценцию. Эти детекторы излучают зеленый свет из областей, где электроны попадают на их поверхность, и они также являются общими для ПЭМ. Экран детектора полезен для настройки оптимального положения и интенсивности рисунка. ПЗС-камеры фиксируют закономерности для проведения цифрового анализа.
Для эффективных экспериментов по RHEED поверхность образца должна быть очень чистой. Загрязнения на поверхности образца мешают электронному лучу и ухудшают качество изображения RHEED. Пользователи RHEED используют два основных метода для создания чистых поверхностей образцов. Небольшие образцы можно расколоть в вакуумной камере перед анализом RHEED. [6] Анализируется вновь обнаженная сколотая поверхность. Большие образцы или те, которые невозможно расколоть перед анализом RHEED, можно перед анализом покрыть слоем пассивного оксида. [6] Последующая термообработка в вакууме камеры RHEED удаляет оксидный слой и обнажает чистую поверхность образца.
Поскольку молекулы газа дифрагируют электроны и влияют на качество электронной пушки, эксперименты RHEED проводятся в вакууме. Система RHEED должна работать при достаточно низком давлении, чтобы предотвратить значительное рассеяние электронных лучей молекулами газа в камере. При энергии электронов 10 кэВ необходимо давление в камере 10 -5 мбар или ниже, чтобы предотвратить значительное рассеяние электронов фоновым газом. [6] На практике системы RHEED работают в условиях сверхвысокого вакуума. Давление в камере максимально сведено к минимуму, чтобы оптимизировать процесс. Условия вакуума ограничивают типы материалов и процессов, которые можно контролировать на месте с помощью RHEED.
Предыдущий анализ был сосредоточен только на дифракции от идеально ровной поверхности кристалла. Однако неплоские поверхности добавляют дополнительные дифракционные условия к анализу RHEED.
Для моделей RHEED характерны полосатые или удлиненные пятна. Как показано на рис. 3, стержни обратной решетки низших порядков пересекают сферу Эвальда под очень малыми углами, поэтому пересечение стержней и сферы не является особой точкой, если сфера и стержни имеют толщину. Падающий электронный пучок расходится, и электроны в луче имеют определенный диапазон энергий, поэтому на практике сфера Эвальда не является бесконечно тонкой, как это теоретически моделируется. Стержни обратной решетки также имеют конечную толщину, а их диаметр зависит от качества поверхности образца. На месте идеальных точек при пересечении сферы Эвальда уширенными стержнями появляются полосы. Условия дифракции выполняются по всему пересечению стержней со сферой, образуя вытянутые точки или «полосы» вдоль вертикальной оси диаграммы ДБЭД. В реальных случаях полосчатая картина RHEED указывает на плоскую поверхность образца, а расширение полос указывает на небольшую область когерентности на поверхности.

Особенности поверхности и поликристаллические поверхности усложняют или меняют рисунок RHEED по сравнению с идеально плоскими поверхностями. Растущие пленки, зародышеобразующие частицы, двойникование кристаллов, зерна разного размера и адсорбированные частицы добавляют сложные условия дифракции к условиям идеальной поверхности. [7] [8] Наложение рисунков подложки и гетерогенных материалов, сложные интерференционные картины и ухудшение разрешения характерны для сложных поверхностей или частично покрытых гетерогенными материалами.
RHEED — чрезвычайно популярный метод мониторинга роста тонких пленок. В частности, RHEED хорошо подходит для использования в молекулярно-лучевой эпитаксии (МЛЭ) — процессе, используемом для формирования высококачественных сверхчистых тонких пленок в условиях выращивания в сверхвысоком вакууме. [9] Интенсивность отдельных пятен на картине ДБЭД периодически колеблется в результате относительного покрытия поверхности растущей тонкой пленки. На рис. 8 показан пример флуктуации интенсивности в одной точке RHEED во время роста MBE.

Каждый полный период соответствует образованию тонкой пленки из одного атомного слоя. Период колебаний сильно зависит от материальной системы, энергии электронов и угла падения, поэтому исследователи получают эмпирические данные для корреляции колебаний интенсивности и покрытия пленки, прежде чем использовать RHEED для мониторинга роста пленки. [6]
На видео 1 изображен метрологический прибор, записывающий колебания интенсивности RHEED и скорости осаждения для контроля процесса и анализа.
Дифракция быстрых электронов на отражение - рентгеновская спектроскопия полного отражения - это метод контроля химического состава кристаллов. [10] RHEED-TRAXS анализирует спектральные линии рентгеновского излучения, испускаемые кристаллом в результате столкновения электронов из пушки RHEED с поверхностью.
RHEED-TRAXS предпочтительнее рентгеновского микроанализа (XMA) (например, EDS и WDS ), поскольку угол падения электронов на поверхность очень мал, обычно менее 5 °. В результате электроны не проникают глубоко в кристалл, а это означает, что рентгеновское излучение ограничивается верхней частью кристалла, что позволяет в режиме реального времени отслеживать стехиометрию поверхности на месте.
Экспериментальная установка достаточно проста. Электроны попадают в образец, вызывая рентгеновское излучение. Эти рентгеновские лучи затем обнаруживаются с помощью кремний - литиевого кристалла Si-Li, помещенного за бериллиевыми окнами, используемого для поддержания вакуума.
MCP-RHEED — это система, в которой электронный луч усиливается микроканальной пластиной (MCP). Эта система состоит из электронной пушки и МКП, оснащенного люминесцентным экраном, расположенным напротив электронной пушки. За счет усиления интенсивность электронного пучка может быть уменьшена на несколько порядков и уменьшено повреждение образцов. Этот метод используется для наблюдения за ростом кристаллов изоляторов , таких как органические пленки и пленки галогенидов щелочных металлов , которые легко повреждаются электронными лучами. [11]