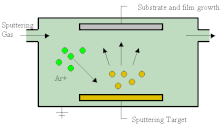
Напыление — это метод физического осаждения из паровой фазы (PVD), при котором наносятся тонкие пленки с помощью явления распыления . Это предполагает выброс материала из «мишени», которая является источником, на «подложку», такую как кремниевая пластина . Повторное распыление — это повторное излучение осажденного материала в процессе осаждения путем бомбардировки ионами или атомами. [1] [2] Распыленные атомы, вылетающие из мишени, имеют широкое распределение энергии, обычно до десятков эВ (100 000 К ). Распыленные ионы (обычно ионизируется лишь небольшая часть выброшенных частиц — порядка 1 процента) могут баллистически вылетать из мишени по прямым линиям и энергично воздействовать на подложки или вакуумную камеру (вызывая повторное распыление). Альтернативно, при более высоких давлениях газа ионы сталкиваются с атомами газа, которые действуют как замедлитель, и движутся диффузионно, достигая подложек или стенок вакуумной камеры и конденсируясь после случайного блуждания . Весь диапазон от высокоэнергетического баллистического удара до низкоэнергетического термализованного движения доступен за счет изменения давления фонового газа. Распыляющий газ часто представляет собой инертный газ, например аргон . Для эффективной передачи импульса атомный вес распыляющего газа должен быть близок к атомному весу мишени, поэтому для распыления легких элементов предпочтителен неон , а для тяжелых - криптон или ксенон . [3] Активные газы также можно использовать для распыления соединений. Соединение может образовываться на поверхности мишени, в полете или на подложке в зависимости от параметров процесса. Наличие многих параметров, которые контролируют напыление, делают этот процесс сложным, но также позволяют специалистам в значительной степени контролировать рост и микроструктуру пленки.
Одним из первых широко распространенных коммерческих применений напыления, которое до сих пор остается одним из наиболее важных его применений, является производство компьютерных жестких дисков . Распыление широко используется в полупроводниковой промышленности для нанесения тонких пленок различных материалов при обработке интегральных схем . Тонкие просветляющие покрытия на стекле для оптических применений также наносятся методом напыления. Из-за низких температур подложки напыление является идеальным методом нанесения контактных металлов для тонкопленочных транзисторов . Еще одним известным применением напыления являются покрытия с низкой излучательной способностью на стекле , используемые в оконных конструкциях с двойным остеклением. Покрытие представляет собой многослойное покрытие, содержащее серебро и оксиды металлов , таких как оксид цинка , оксид олова или диоксид титана . Крупная промышленность развилась вокруг покрытия долот инструментов с использованием напыленных нитридов, таких как нитрид титана , создавая знакомое твердое покрытие золотого цвета. Напыление также используется в качестве процесса нанесения слоя металла (например, алюминия) при изготовлении компакт-дисков и DVD-дисков.
На поверхности жестких дисков используется напыленный CrO x и другие напыленные материалы. Напыление — один из основных процессов производства оптических волноводов и еще один способ изготовления эффективных фотоэлектрических солнечных элементов.
В 2022 году исследователи из IMEC создали лабораторные сверхпроводящие кубиты со временем когерентности, превышающим 100 мкс , и средней точностью однокубитного затвора 99,94%, используя КМОП -совместимые методы изготовления, такие как напыление и субтрактивное травление. [4]

Напыление покрытия в сканирующей электронной микроскопии — это процесс напыления [ необходимы пояснения ] для покрытия образца тонким слоем проводящего материала, обычно металла, такого как сплав золота и палладия (Au/Pd). Проводящее покрытие необходимо для предотвращения зарядки образца электронным лучом в обычном режиме СЭМ (высокий вакуум, высокое напряжение). Хотя металлические покрытия также полезны для увеличения отношения сигнал/шум (тяжелые металлы являются хорошими эмиттерами вторичных электронов), они имеют худшее качество при использовании рентгеновской спектроскопии . По этой причине при использовании рентгеновской спектроскопии предпочтительным является углеродное покрытие. [5]

Важным преимуществом напыления является то, что даже материалы с очень высокими температурами плавления легко распыляются, тогда как испарение этих материалов в резистивном испарителе или ячейке Кнудсена проблематично или невозможно. Напыленные пленки имеют состав, близкий к составу исходного материала. Разница обусловлена тем, что разные элементы распространяются по-разному из-за разной массы (легкие элементы легче отклоняются газом), но эта разница постоянна. Напыленные пленки обычно имеют лучшую адгезию к подложке, чем напыленные пленки. Мишень содержит большое количество материала и не требует технического обслуживания, что делает этот метод пригодным для применения в сверхвысоком вакууме. Источники распыления не содержат горячих частей (во избежание нагрева они обычно охлаждаются водой) и совместимы с химически активными газами, такими как кислород. Напыление может осуществляться сверху вниз, тогда как испарение должно осуществляться снизу вверх. Возможны продвинутые процессы, такие как эпитаксиальный рост.
Некоторые недостатки процесса напыления заключаются в том, что этот процесс сложнее совместить с отрывом для структурирования пленки. Это связано с тем, что диффузный перенос, характерный для распыления, делает невозможным создание полной тени. Таким образом, невозможно полностью ограничить направление движения атомов, что может привести к проблемам загрязнения. Кроме того, активный контроль послойного роста затруднен по сравнению с импульсным лазерным осаждением, а инертные газы распыления внедряются в растущую пленку в качестве примесей. Импульсное лазерное напыление — это вариант метода напыления, при котором для распыления используется лазерный луч. Роль распыленных и повторных ионов, а также фонового газа полностью исследована в процессе импульсного лазерного осаждения. [6] [7]

В источниках распыления часто используются магнетроны , которые используют сильные электрические и магнитные поля для удержания заряженных частиц плазмы вблизи поверхности мишени распыления. В магнитном поле электроны следуют по спиральным траекториям вокруг силовых линий магнитного поля, подвергаясь большему количеству ионизирующих столкновений с газообразными нейтралами вблизи поверхности мишени, чем могло бы произойти в противном случае. (Поскольку материал мишени истощается, на поверхности мишени может появиться профиль эрозии «беговой дорожки».) Газом для распыления обычно является инертный газ, такой как аргон. Дополнительные ионы аргона, образующиеся в результате этих столкновений, приводят к более высокой скорости осаждения. Таким образом , плазма также может поддерживаться при более низком давлении. Распыленные атомы нейтрально заряжены и поэтому не подвержены влиянию магнитной ловушки. Накопления заряда на изолирующих мишенях можно избежать с помощью высокочастотного распыления , при котором знак смещения анод-катод изменяется с высокой скоростью (обычно 13,56 МГц ). [8] ВЧ-напыление хорошо подходит для производства оксидных пленок с высокими изолирующими свойствами, но требует дополнительных затрат на ВЧ-источники питания и схемы согласования импеданса . Рассеянные магнитные поля, возникающие из ферромагнитных мишеней, также нарушают процесс распыления. В качестве компенсации часто приходится использовать специально разработанные распылительные пистолеты с необычайно сильными постоянными магнитами.

Ионно-лучевое распыление (IBS) — это метод, в котором мишень находится вне источника ионов . Источник может работать без какого-либо магнитного поля, как ионизационный датчик с горячей нитью . В источнике Кауфмана ионы генерируются в результате столкновений с электронами, которые удерживаются магнитным полем, как в магнетроне. Затем они ускоряются электрическим полем, исходящим от сетки к цели. Когда ионы покидают источник, они нейтрализуются электронами второй внешней нити. Преимущество IBS состоит в том, что энергию и поток ионов можно контролировать независимо. Поскольку поток, попадающий на мишень, состоит из нейтральных атомов, можно распылять как изолирующие, так и проводящие мишени. Компания IBS нашла применение при производстве тонкопленочных головок для дисководов . Градиент давления между источником ионов и камерой для образца создается путем размещения впускного отверстия для газа у источника и подачи газа через трубку в камеру для образца. Это экономит газ и снижает загрязнение при использовании сверхвысокого напряжения . Принципиальным недостатком IBS является большой объем технического обслуживания, необходимый для поддержания работы источника ионов. [9]
При реактивном распылении распыленные частицы из мишенного материала вступают в химическую реакцию, целью которой является осаждение пленки различного состава на определенной подложке. Химическая реакция, в которой подвергаются частицы, происходит с химически активным газом, введенным в камеру распыления, таким как кислород или азот, что позволяет производить оксидные и нитридные пленки соответственно. [10] Введение в процесс дополнительного элемента, то есть химически активного газа, оказывает значительное влияние на желаемые осаждения, что затрудняет поиск идеальных рабочих точек. Таким образом, подавляющее большинство процессов реактивного распыления характеризуются поведением, подобным гистерезису, поэтому для его устранения требуется надлежащий контроль задействованных параметров, например, парциального давления рабочего (или инертного) и реакционноспособного газов. [11] Берг и др. предложил важную модель, т.е. модель Берга, для оценки воздействия добавления химически активного газа в процессах распыления. Обычно влияние относительного давления и расхода реактивного газа оценивали в соответствии со скоростью эрозии мишени и скоростью осаждения пленки на желаемой подложке. [12] Состав пленки можно контролировать, изменяя относительные давления инертных и химически активных газов. Стехиометрия пленки является важным параметром для оптимизации функциональных свойств, таких как напряжение в SiN x и показатель преломления SiO x .
При ионно-активированном осаждении (IAD) подложка подвергается воздействию вторичного ионного пучка, работающего с меньшей мощностью, чем распылительный пистолет. Обычно источник Кауфмана, подобный тому, который используется в IBS, обеспечивает вторичный пучок. IAD можно использовать для нанесения углерода на подложку в алмазоподобной форме . Любые атомы углерода, попадающие на подложку и не способные должным образом соединиться в кристаллической решетке алмаза, будут отброшены вторичным лучом. НАСА использовало этот метод для экспериментов по нанесению алмазных пленок на лопатки турбин в 1980-х годах. IAD используется и в других важных промышленных приложениях, таких как создание поверхностных покрытий из тетраэдрического аморфного углерода на пластинах жестких дисков и твердых покрытий из нитрида переходных металлов на медицинских имплантатах.

Распыление также может осуществляться путем удаленной генерации плазмы высокой плотности. Плазма генерируется в боковой камере, ведущей в основную технологическую камеру, содержащую мишень и подложку, на которую будет нанесено покрытие. Поскольку плазма генерируется удаленно, а не из самой мишени (как при обычном магнетронном распылении), ионный ток к мишени не зависит от приложенного к мишени напряжения.
HiPIMS — это метод физического осаждения тонких пленок из паровой фазы, основанный на осаждении магнетронным распылением. HiPIMS использует чрезвычайно высокую плотность мощности порядка кВт/см 2 в коротких импульсах (импульсах) длительностью в десятки микросекунд при низком рабочем цикле < 10%.
В газовом распылении используется эффект полого катода , тот же эффект, благодаря которому работают лампы с полым катодом . При газовом распылении рабочий газ, например аргон , подается через отверстие в металле, находящемся под отрицательным электрическим потенциалом. [13] [14] Повышенная плотность плазмы возникает в полом катоде, если давление в камере p и характерный размер L полого катода подчиняются закону Пашена 0,5 Па·м < p · L < 5 Па·м. Это вызывает высокий поток ионов на окружающие поверхности и сильный эффект распыления. Таким образом, распыление газовым потоком на основе полого катода может быть связано с большими скоростями осаждения, вплоть до значений в несколько мкм/мин. [15]
В 1974 году Дж. А. Торнтон применил зонную модель структуры для описания морфологии тонких пленок при осаждении методом распыления. В исследовании металлических слоев, полученных методом напыления постоянным током, он [16] расширил концепцию структурных зон, первоначально введенную Мовчаном и Демчишиным для напыленных пленок . [17] Торнтон представил еще одну структурную зону Т, которая наблюдалась при низких давлениях аргона и характеризовалась плотно упакованными волокнистыми зернами. Самым важным моментом этого расширения было подчеркнуть давление p как решающий параметр процесса. В частности, если для сублимации исходных атомов используются гипертермические методы, такие как распыление и т. д. , давление через длину свободного пробега определяет распределение энергии, с которой они падают на поверхность растущей пленки. Таким образом, при рассмотрении процесса осаждения рядом с температурой осаждения T d всегда следует указывать давление в камере или среднюю длину свободного пробега.
Поскольку напыление относится к группе плазменных процессов, на поверхность растущей пленки попадают не только нейтральные атомы, но и заряженные частицы (например, ионы аргона), и этот компонент может оказывать большое влияние. Обозначив потоки прилетающих ионов и атомов через J i и J a , оказалось, что величина отношения J i /J a играет решающую роль в микроструктуре и морфологии полученной пленки. [18] Эффект ионной бомбардировки может быть количественно выведен из структурных параметров, таких как предпочтительная ориентация кристаллитов или текстура , а также из состояния остаточного напряжения . Недавно было показано [19] , что текстуры и остаточные напряжения могут возникать в слоях Ti, распыленных газовым потоком, по сравнению с текстурами, полученными в макроскопических заготовках Ti, подвергнутых сильной пластической деформации путем дробеструйной обработки .