
Полевой транзистор металл -оксид-полупроводник ( MOSFET , MOS-FET или MOS FET ) — это тип полевого транзистора (FET), чаще всего изготавливаемый путем контролируемого окисления кремния . Он имеет изолированный затвор, напряжение которого определяет проводимость устройства. Эту способность изменять проводимость в зависимости от величины приложенного напряжения можно использовать для усиления или переключения электронных сигналов . Термин « полевой транзистор металл-изолятор-полупроводник» ( MISFET ) практически синоним MOSFET . Другой почти синоним — полевой транзистор с изолированным затвором ( IGFET ).
Основной принцип полевого транзистора был впервые запатентован Юлиусом Эдгаром Лилиенфельдом в 1925 году . [1]
Основное преимущество МОП-транзистора заключается в том, что он практически не требует входного тока для управления током нагрузки по сравнению с биполярными транзисторами (транзисторы с биполярным переходом/BJT). В режиме улучшения MOSFET напряжение, приложенное к выводу затвора, увеличивает проводимость устройства. В транзисторах с режимом истощения напряжение, приложенное к затвору, снижает проводимость. [2]
Слово «металл» в названии МОП-транзистора иногда используется неправильно , поскольку материалом затвора может быть слой поликремния (поликристаллического кремния). Точно так же слово «оксид» в названии может быть неправильным, поскольку с целью получения прочных каналов с меньшим приложенным напряжением используются разные диэлектрические материалы.
МОП-транзистор на сегодняшний день является наиболее распространенным транзистором в цифровых схемах, поскольку в микросхеме памяти или микропроцессоре могут быть включены миллиарды транзисторов. Поскольку МОП-транзисторы могут быть изготовлены как из полупроводников p-типа, так и из n-типа, комплементарные пары МОП-транзисторов могут использоваться для создания переключающих схем с очень низким энергопотреблением в форме КМОП-логики .


Основной принцип работы такого транзистора был впервые запатентован Юлиусом Эдгаром Лилиенфельдом в 1925 году. [1]
Структура, напоминающая МОП-транзистор, была предложена учёными Bell Уильямом Шокли , Джоном Бардином и Уолтером Хаузером Брэттеном в ходе их исследования, приведшего к открытию транзисторного эффекта. Структура не продемонстрировала ожидаемых эффектов из-за проблемы поверхностного состояния: ловушек на поверхности полупроводника, которые удерживают электроны неподвижно. В 1955 году Карл Фрош и Л. Дерик случайно вырастили слой диоксида кремния поверх кремниевой пластины. Дальнейшие исследования показали, что диоксид кремния может препятствовать диффузии легирующих примесей в кремниевую пластину. Основываясь на этой работе, Мохамед М. Аталла показал, что диоксид кремния очень эффективен в решении проблемы одного важного класса поверхностных состояний. [3]
В 1960-х годах после этого исследования Мохамед Аталла и Давон Кан продемонстрировали [4] устройство, имевшее структуру современного МОП-транзистора. Принципы устройства были такими же, как те, которые опробовали Бардин, Шокли и Брэттейн в их неудачной попытке создать поверхностное полевое устройство.
Устройство было примерно в 100 раз медленнее современных биполярных транзисторов и поначалу считалось худшим. Тем не менее Кан отметил несколько преимуществ устройства, в частности простоту изготовления и его применения в интегральных схемах . [5]

Обычно предпочтительным полупроводником является кремний . Некоторые производители микросхем, особенно IBM и Intel , используют в каналах MOSFET сплав кремния и германия ( SiGe ). [ нужна цитация ] Многие полупроводники с лучшими электрическими свойствами, чем кремний, такие как арсенид галлия , не образуют хороших интерфейсов полупроводник-изолятор и, следовательно, не подходят для МОП-транзисторов. Продолжаются исследования по созданию изоляторов с приемлемыми электрическими характеристиками на других полупроводниковых материалах.
Чтобы преодолеть увеличение энергопотребления из-за утечки тока затвора, вместо диоксида кремния в качестве изолятора затвора используется диэлектрик с высоким κ , а поликремний заменяется металлическими затворами (например, Intel , 2009). [6]
Затвор отделен от канала тонким изолирующим слоем, традиционно состоящим из диоксида кремния, а затем из оксинитрида кремния . Некоторые компании используют комбинацию диэлектрика с высоким κ и металлического затвора в узле 45 нанометров .
Когда напряжение прикладывается между выводами затвора и корпуса, генерируемое электрическое поле проникает через оксид и создает инверсионный слой или канал на границе раздела полупроводник-изолятор. Инверсионный слой обеспечивает канал, по которому ток может проходить между клеммами истока и стока. Изменение напряжения между затвором и телом модулирует проводимость этого слоя и тем самым контролирует поток тока между стоком и истоком. Это называется режимом улучшения.
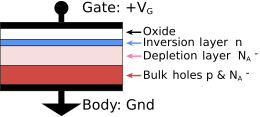
Традиционная структура металл-оксид-полупроводник (МОП) получается путем выращивания слоя диоксида кремния ( SiO
2) поверх кремниевой подложки, обычно путем термического оксидирования и нанесения слоя металла или поликристаллического кремния (обычно используется последний). Поскольку диоксид кремния является диэлектрическим материалом, его структура эквивалентна планарному конденсатору , в котором один из электродов заменен полупроводником.
Когда напряжение прикладывается к МОП-структуре, оно изменяет распределение зарядов в полупроводнике. Если мы рассмотрим полупроводник p-типа (с плотностью акцепторов p плотность дырок; p = NA в нейтральном объеме), положительное напряжение от затвора к телу (см. рисунок) создает слой обеднения , заставляя положительно заряженные дырки удаляются от границы раздела затвор-изолятор/полупроводник, оставляя открытой область без носителей неподвижных отрицательно заряженных ионов-акцепторов (см. Легирование ). Если оно достаточно велико, то в инверсионном слое , расположенном в тонком слое рядом с границей раздела полупроводник-изолятор, образуется высокая концентрация отрицательных носителей заряда .
Условно пороговым напряжением называют напряжение на затворе, при котором объемная плотность электронов в инверсионном слое равна объемной плотности дырок в теле . Когда напряжение между затвором и истоком транзистора ( VGS ) превышает пороговое напряжение ( Vth ), эта разница называется напряжением перегрузки .
Эта структура с корпусом p-типа является основой MOSFET n-типа, который требует добавления областей истока и стока n-типа.
Структура МОП-конденсатора является сердцем МОП-транзистора. Рассмотрим МОП-конденсатор с кремниевой основой p-типа. Если к затвору приложено положительное напряжение, отверстия, находящиеся на поверхности подложки p-типа, будут отталкиваться электрическим полем, создаваемым приложенным напряжением. Сначала дырки будут просто отталкиваться и на поверхности останутся неподвижные (отрицательные) атомы акцепторного типа, что создает на поверхности область обеднения. Дырка создается атомом-акцептором, например, бором, у которого на один электрон меньше, чем у кремния. Дыры на самом деле не отталкиваются, поскольку они не являются сущностями; Электроны притягиваются положительным полем и заполняют эти дырки. Это создает область обеднения, в которой не существует носителей заряда, поскольку электрон теперь прикреплен к атому и неподвижен.
По мере увеличения напряжения на затворе наступит точка, в которой поверхность над обедненной областью будет преобразована из p-типа в n-тип, поскольку электроны из объемной области начнут притягиваться более сильным электрическим полем. Это известно как инверсия . Пороговое напряжение, при котором происходит это преобразование, является одним из наиболее важных параметров MOSFET.
В случае МОП-транзистора p-типа объемная инверсия происходит, когда уровень собственной энергии на поверхности становится меньше уровня Ферми на поверхности. Это можно увидеть на полосовой диаграмме. Уровень Ферми определяет тип обсуждаемого полупроводника. Если уровень Ферми равен внутреннему уровню, полупроводник относится к собственному или чистому типу. Если уровень Ферми лежит ближе к зоне проводимости (валентной зоне), то тип полупроводника будет n-типа (p-типа).
Когда напряжение затвора увеличивается в положительном смысле (для данного примера), [ уточняйте ] это сместит полосу собственных уровней энергии так, что она будет изгибаться вниз по направлению к валентной зоне. Если уровень Ферми лежит ближе к валентной зоне (для p-типа), наступит момент, когда внутренний уровень начнет пересекать уровень Ферми, и когда напряжение достигнет порогового напряжения, собственный уровень действительно пересечет уровень Ферми. , и это то, что известно как инверсия. В этот момент поверхность полупроводника преобразуется из p-типа в n-тип.
Если уровень Ферми лежит выше собственного уровня, полупроводник относится к n-типу, поэтому при инверсии, когда собственный уровень достигает и пересекает уровень Ферми (который лежит ближе к валентной зоне), тип полупроводника меняется на поверхности как диктуется относительным положением уровней Ферми и собственной энергии.

МОП-транзистор основан на модуляции концентрации заряда с помощью МОП-емкости между электродом корпуса и электродом затвора , расположенным над корпусом и изолированным от всех других областей устройства диэлектрическим слоем затвора. Если используются диэлектрики, отличные от оксида, устройство можно назвать полевым транзистором металл-изолятор-полупроводник (MISFET). По сравнению с МОП-конденсатором, МОП-транзистор включает в себя два дополнительных вывода ( исток и сток ), каждый из которых подключен к отдельным высоколегированным областям, разделенным основной областью. Эти области могут быть либо p-, либо n-типа, но оба они должны быть одного и того же типа и противоположного типа области тела. Исток и сток (в отличие от корпуса) сильно легированы, о чем свидетельствует знак «+» после типа легирования.
Если МОП-транзистор является n-канальным или nМОП-транзистором, то истоком и стоком являются области n+ , а тело — область p . Если МОП-транзистор является p-канальным или pMOS FET, то истоком и стоком являются области p+ , а тело — область n . Источник назван так потому, что он является источником носителей заряда (электронов для n-канала, дырок для p-канала), протекающих через канал; аналогично сток - это место, где носители заряда покидают канал.
Заселенность энергетических зон в полупроводнике определяется положением уровня Ферми относительно краев энергетических зон полупроводника.
При достаточном напряжении на затворе край валентной зоны отодвигается далеко от уровня Ферми, а дырки из тела удаляются от затвора.
При большем смещении затвора вблизи поверхности полупроводника край зоны проводимости приближается к уровню Ферми, заселяя поверхность электронами в инверсионном слое или n-канале на границе между p-областью и оксидом. Этот проводящий канал проходит между истоком и стоком, и через него проходит ток, когда между двумя электродами подается напряжение. Увеличение напряжения на затворе приводит к увеличению плотности электронов в инверсионном слое и, следовательно, к увеличению тока между истоком и стоком. При напряжениях на затворе ниже порогового значения канал заполняется слабо, и между истоком и стоком может протекать только очень небольшой подпороговой ток утечки .
Когда прикладывается отрицательное напряжение затвор-исток (положительное напряжение исток-затвор), оно создает p-канал на поверхности n-области, аналогичный случаю n-канала, но с противоположными полярностями зарядов и напряжений. Когда между затвором и истоком прикладывается напряжение, менее отрицательное, чем пороговое значение (отрицательное напряжение для p-канала), канал исчезает, и между истоком и стоком может течь только очень небольшой подпороговый ток. Устройство может содержать устройство «кремний на изоляторе» , в котором под тонким полупроводниковым слоем образуется скрытый оксид. Если область канала между диэлектриком затвора и областью скрытого оксида очень тонкая, канал называется сверхтонкой областью канала с областями истока и стока, сформированными по обе стороны в тонком полупроводниковом слое или над ним. Могут быть использованы другие полупроводниковые материалы. Когда области истока и стока формируются над каналом полностью или частично, их называют приподнятыми областями истока/стока.


Работу МОП-транзистора можно разделить на три различных режима, в зависимости от напряжения на выводах. В следующем обсуждении используется упрощенная алгебраическая модель. [9] Характеристики современных МОП-транзисторов более сложны, чем представленная здесь алгебраическая модель. [10]
Для n-канального MOSFET режима улучшения существуют три режима работы:
Когда V GS < V th :
где – смещение затвор-исток, а – пороговое напряжение устройства.
Согласно базовой пороговой модели, транзистор выключен, и проводимость между стоком и истоком отсутствует. Более точная модель учитывает влияние тепловой энергии на распределение энергий электронов Ферми – Дирака , которое позволяет некоторым из более энергичных электронов в источнике проникать в канал и течь в сток. Это приводит к подпорогому току, который является экспоненциальной функцией напряжения затвор-исток. Хотя ток между стоком и истоком в идеале должен быть равен нулю, когда транзистор используется в качестве выключателя, существует слабый инверсионный ток, иногда называемый подпороговой утечкой.
При слабой инверсии, когда источник привязан к объему, ток изменяется экспоненциально, примерно как: [11] [12]
где = ток при , тепловое напряжение и коэффициент наклона n определяются по формуле:
где = емкость обедненного слоя и = емкость оксидного слоя. Это уравнение обычно используется, но оно является лишь адекватным приближением для источника, привязанного к объему. Для источника, не привязанного к объему, подпороговое уравнение для тока стока в режиме насыщения имеет вид [13] [14]
В устройстве с длинным каналом зависимость тока от напряжения стока отсутствует , но по мере уменьшения длины канала снижение барьера, вызванное стоком, приводит к зависимости напряжения стока, которая сложным образом зависит от геометрии устройства (например, от легирования канала). , легирование перехода и так далее). Часто пороговое напряжение V th для этого режима определяется как напряжение затвора, при котором возникает выбранное значение тока I D0 , например, I D0 = 1 мкА, которое может не совпадать с тем же значением V th , которое используется в уравнениях для следующие режимы.
Некоторые аналоговые схемы микромощности разработаны с учетом преимуществ подпороговой проводимости. [15] [16] [17] Работая в области слабой инверсии, МОП-транзисторы в этих схемах обеспечивают максимально возможное соотношение крутизны к току, а именно: , почти такое же, как у биполярного транзистора. [18]
Подпороговая ВАХ зависит экспоненциально от порогового напряжения, создавая сильную зависимость от любых производственных изменений, влияющих на пороговое напряжение; например: изменения толщины оксида, глубины перехода или легирования тела, которые изменяют степень снижения барьера, вызванного стоком. Возникающая в результате чувствительность к производственным вариациям усложняет оптимизацию утечек и производительности. [19] [20]
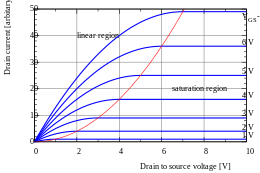


Когда V GS > V th и V DS < V GS − V th :
Транзистор включается, и создается канал, пропускающий ток между стоком и истоком. МОП-транзистор работает как резистор, управляемый напряжением затвора относительно напряжений истока и стока. Ток от стока к истоку моделируется как:
где – эффективная подвижность носителей заряда, – ширина затвора, – длина затвора, – оксидная емкость затвора на единицу площади. Переход из экспоненциальной подпороговой области в триодную область не такой резкий, как предполагают уравнения. [21] [22] [ нужна проверка ]
Когда V GS > V th и V DS ≥ (V GS – V th ):
Переключатель включен, и создан канал, который пропускает ток между стоком и истоком. Поскольку напряжение стока выше, чем напряжение истока, электроны распространяются, и проводимость осуществляется не через узкий канал, а через более широкое, двух- или трехмерное распределение тока, простирающееся от границы раздела и глубже в подложку. Начало этой области также известно как отсечение , что указывает на отсутствие области канала возле стока. Хотя канал не простирается на всю длину устройства, электрическое поле между стоком и каналом очень велико, и проводимость сохраняется. Ток стока теперь слабо зависит от напряжения стока и контролируется в основном напряжением затвор-исток и моделируется примерно как:
Дополнительный фактор, включающий λ, параметр модуляции длины канала, моделирует зависимость тока от напряжения стока из-за эффекта Раннего или модуляции длины канала . Согласно этому уравнению, ключевым параметром конструкции, крутизной МОП-транзистора, является:
где комбинация V ov = V GS - V th называется напряжением перегрузки , [23] и где V DSsat = V GS - V th приводит к небольшому разрыву, который в противном случае возник бы при переходе между триодом и областями насыщения.
Другим ключевым параметром конструкции является выходное сопротивление MOSFET r out , определяемое формулой:
r out является обратным g DS, где . I D – выражение в области насыщения.
Если λ принимается за ноль, получается бесконечное выходное сопротивление устройства, что приводит к нереалистичным прогнозам схемы, особенно в аналоговых схемах.
Поскольку длина канала становится очень короткой, эти уравнения становятся совершенно неточными. Возникают новые физические эффекты. Например, транспортировка несущей в активном режиме может стать ограниченной из-за насыщения скорости . Когда преобладает насыщение по скорости, ток стока насыщения является скорее линейным, чем квадратичным по VGS . На еще более коротких длинах носители переносятся с почти нулевым рассеянием, известным как квазибаллистический транспорт . В баллистическом режиме носители движутся со скоростью инжекции, которая может превышать скорость насыщения и приближаться к скорости Ферми при высокой плотности инверсионного заряда. Кроме того, снижение барьера, индуцированное стоком, увеличивает ток закрытого состояния (отсечки) и требует увеличения порогового напряжения для компенсации, что, в свою очередь, снижает ток насыщения. [24] [25] [ нужна проверка ]

Заселенность энергетических зон в полупроводнике определяется положением уровня Ферми относительно краев энергетических зон полупроводника. Применение обратного смещения pn-перехода между источником и подложкой приводит к расколу между уровнями Ферми для электронов и дырок, перемещая уровень Ферми для канала дальше от края зоны, уменьшая заселенность канала. В результате увеличивается напряжение затвора, необходимое для установления канала, как показано на рисунке. Это изменение силы канала за счет применения обратного смещения называется «эффектом тела».
Проще говоря, на примере nMOS, смещение затвор-тело V GB позиционирует уровни энергии зоны проводимости, в то время как смещение источник-тело V SB позиционирует уровень Ферми электронов вблизи границы раздела, определяя заселенность этих уровней вблизи границы раздела. интерфейс и, следовательно, мощность инверсионного слоя или канала.
Эффект тела на канал можно описать, используя модификацию порогового напряжения, аппроксимируемую следующим уравнением:
где V TB — пороговое напряжение при наличии смещения подложки, а V T0 — значение порогового напряжения при нулевом В SB , параметр объемного эффекта, а 2 φ B — приблизительное падение потенциала между поверхностью и объемом на обедненном слое, когда V SB = 0 и смещение затвора достаточно, чтобы гарантировать наличие канала. [26] Как показывает это уравнение, обратное смещение V SB > 0 вызывает увеличение порогового напряжения V TB и, следовательно, требует большего напряжения затвора, прежде чем канал заполнится.
Кузов может использоваться как вторые ворота, и его иногда называют «задними воротами»; Эффект тела иногда называют «эффектом задних ворот». [27]
Для MOSFET используются различные символы. Базовая конструкция обычно представляет собой линию канала, в которой исток и сток выходят из нее под прямым углом, а затем изгибаются под прямым углом в том же направлении, что и канал. Иногда для режима улучшения используются три сегмента линии , а для режима истощения — сплошная линия (см. Режимы истощения и улучшения ). Еще одна линия проводится параллельно каналу для ворот.
Объемное или корпусное соединение, если оно показано, показано подключенным к задней части канала со стрелкой, указывающей pMOS или nMOS. Стрелки всегда указывают от P к N, поэтому в NMOS (N-канал в P-лунке или P-подложке) стрелка указывает внутрь (от объема к каналу). Если основная часть подключена к истоку (как это обычно бывает с дискретными устройствами), иногда она располагается под углом, чтобы встретиться с источником, выходящим из транзистора. Если основная часть не показана (как это часто бывает в конструкции ИС, поскольку они, как правило, представляют собой обычную основную часть), иногда используется символ инверсии для обозначения PMOS, в качестве альтернативы можно использовать стрелку на источнике так же, как для биполярных транзисторов ( выход для nMOS, вход для pMOS).
Сравнение символов MOSFET в режиме улучшения и режима истощения, а также символов JFET . Ориентация символов (особенно положение истока относительно стока) такова, что более положительные напряжения появляются на странице выше, чем менее положительные напряжения, подразумевая, что обычный ток течет «вниз» по странице: [28] [29] [ 30]
На схемах, где G, S, D не обозначены, подробные характеристики символа указывают, какая клемма является источником, а какая — стоком. Для символов MOSFET в режиме улучшения и режима истощения (во втором и пятом столбцах) исходным выводом является разъем, подключенный к треугольнику. Кроме того, на этой диаграмме ворота показаны в форме буквы «L», входная часть которых ближе к S, чем к D, что также указывает, что есть что. Однако эти символы часто изображаются с Т-образным затвором (как и везде на этой странице), поэтому для обозначения исходного терминала следует полагаться на треугольник.
Символами, на которых изображена основная часть или корпус терминала, здесь показано его внутреннее соединение с источником (т. е. черные треугольники на диаграммах в столбцах 2 и 5). Это типичная конфигурация, но ни в коем случае не единственная важная конфигурация. В общем, МОП-транзистор представляет собой устройство с четырьмя выводами, и в интегральных схемах многие из МОП-транзисторов имеют общее соединение корпуса, не обязательно подключенное к клеммам истока всех транзисторов.
Цифровые интегральные схемы, такие как микропроцессоры и устройства памяти, содержат от тысяч до миллионов и миллиардов встроенных MOSFET-транзисторов на каждом устройстве, обеспечивающих основные функции переключения, необходимые для реализации логических элементов и хранения данных . Дискретные устройства широко используются в таких приложениях, как импульсные источники питания , преобразователи частоты и другие приложения силовой электроники , где каждое устройство может коммутировать тысячи ватт. Усилители радиочастот до диапазона УВЧ используют МОП-транзисторы в качестве усилителей аналогового сигнала и мощности. Радиосистемы также используют МОП-транзисторы в качестве генераторов или смесителей для преобразования частот. Устройства MOSFET также применяются в усилителях мощности звуковой частоты для систем громкой связи, звукоусиления , а также домашних и автомобильных звуковых систем .
После разработки чистых помещений для снижения загрязнения до уровней, которые раньше считались необходимыми, а также фотолитографии [31] и планарного процесса , позволяющего изготавливать схемы за несколько шагов, система Si-SiO 2 обладала техническими преимуществами низкой стоимости. производительность (по каждому контуру) и простота интеграции. Во многом из-за этих двух факторов MOSFET стал наиболее широко используемым типом транзисторов в Институте инженерии и технологий (IET). [ нужна цитата ]
Компания General Microelectronics представила первую коммерческую интегральную схему МОП в 1964 году . небольшая мощность, за исключением случаев фактического переключения.
Самые ранние микропроцессоры, начиная с 1970 года, были микропроцессорами МОП ; т. е. полностью изготовлен на основе логики PMOS или полностью изготовлен на основе логики NMOS . В 1970-х годах МОП-микропроцессоры часто противопоставляли КМОП-микропроцессорам и биполярным побитовым процессорам . [33]
МОП-транзистор используется в цифровой комплементарной логике металл-оксид-полупроводник ( КМОП ), [34] в которой в качестве строительных блоков используются p- и n-канальные МОП-транзисторы. Перегрев является серьезной проблемой в интегральных схемах , поскольку все больше транзисторов помещается в микросхемы все меньшего размера. Логика КМОП снижает энергопотребление, поскольку ток не течет (в идеале) и, следовательно, мощность не потребляется, за исключением случаев, когда входы логических элементов переключаются. CMOS достигает этого снижения тока, дополняя каждый nMOSFET pMOSFET и соединяя оба затвора и оба стока вместе. Высокое напряжение на затворах приведет к тому, что n-MOSFET будет проводить ток, а pMOSFET - нет, а низкое напряжение на затворах приведет к обратному. Во время переключения напряжения, когда напряжение переходит из одного состояния в другое, оба МОП-транзистора кратковременно проводят ток. Такое расположение значительно снижает энергопотребление и выделение тепла.
Развитие цифровых технологий, таких как микропроцессоры , послужило стимулом для развития технологии MOSFET быстрее, чем любого другого типа кремниевых транзисторов. [35] Большим преимуществом МОП-транзисторов для цифровой коммутации является то, что оксидный слой между затвором и каналом предотвращает протекание постоянного тока через затвор, что еще больше снижает энергопотребление и обеспечивает очень большое входное сопротивление. Изолирующий оксид между затвором и каналом эффективно изолирует МОП-транзистор в одном логическом каскаде от более ранних и последующих каскадов, что позволяет одному выходу МОП-транзистора управлять значительным количеством входов МОП-транзистора. Логика на основе биполярных транзисторов (например, TTL ) не имеет такой высокой пропускной способности. Эта изоляция также позволяет разработчикам в некоторой степени игнорировать эффекты загрузки между независимыми логическими этапами. Эта степень определяется рабочей частотой: с увеличением частоты входное сопротивление МОП-транзисторов уменьшается.
Преимущества MOSFET в цифровых схемах не приводят к превосходству во всех аналоговых схемах . Два типа схем основаны на разных особенностях поведения транзисторов. Цифровые схемы переключаются, проводя большую часть времени либо полностью включенным, либо полностью выключенным. Переход от одного к другому вызывает беспокойство только в отношении скорости и требуемого заряда. Аналоговые схемы зависят от работы в переходной области, где небольшие изменения V gs могут модулировать выходной ток (сток). JFET и биполярный переходной транзистор (BJT) предпочтительны для точного согласования (соседних устройств в интегральных схемах), более высокой крутизны и определенных температурных характеристик, которые упрощают поддержание предсказуемости производительности при изменении температуры схемы.
Тем не менее, МОП-транзисторы широко используются во многих типах аналоговых схем из-за их собственных преимуществ (нулевой ток затвора, высокий и регулируемый выходной импеданс и улучшенная надежность по сравнению с биполярными транзисторами, которые могут необратимо ухудшиться даже при незначительном разрушении базы эмиттера). [ неопределенно ] Характеристики и производительность многих аналоговых схем можно увеличивать или уменьшать, изменяя размеры (длину и ширину) используемых МОП-транзисторов. Для сравнения, в биполярных транзисторах действует другой закон масштабирования . Идеальные характеристики МОП-транзисторов в отношении тока затвора (ноль) и напряжения смещения сток-исток (ноль) также делают их почти идеальными переключающими элементами, а также делают практичными аналоговые схемы с переключаемыми конденсаторами . В своей линейной области МОП-транзисторы могут использоваться в качестве прецизионных резисторов, которые могут иметь гораздо более высокое контролируемое сопротивление, чем биполярные транзисторы. В цепях большой мощности МОП-транзисторы иногда имеют то преимущество, что не страдают от теплового разгона , как это происходит с биполярными транзисторами. [ сомнительно ] Это означает, что полные аналоговые схемы могут быть изготовлены на кремниевом чипе, занимая гораздо меньше места и используя более простые технологии изготовления. МОП-транзисторы идеально подходят для переключения индуктивных нагрузок из-за устойчивости к индуктивной отдаче .
Некоторые микросхемы объединяют аналоговые и цифровые схемы MOSFET в одной интегральной схеме смешанных сигналов , что делает необходимое пространство на плате еще меньше. Это создает необходимость изолировать аналоговые схемы от цифровых на уровне микросхемы, что приводит к использованию изолирующих колец и кремния на изоляторе (SOI). Поскольку МОП-транзисторам требуется больше места для обработки заданного количества энергии, чем биполярным транзисторам, в процессе производства можно объединить биполярные транзисторы и МОП-транзисторы в одно устройство. Устройства со смешанными транзисторами называются bi-FET (биполярные полевые транзисторы), если они содержат только один BJT-FET, и BiCMOS (биполярный КМОП), если они содержат дополнительные BJT-FET. Такие устройства имеют преимущества как изолированных затворов, так и более высокой плотности тока.
Аналоговые переключатели MOSFET используют MOSFET для передачи аналоговых сигналов во включенном состоянии и в качестве высокого импеданса в выключенном состоянии. Сигналы проходят через МОП-транзистор в обоих направлениях. В этом приложении сток и исток МОП-транзистора меняются местами в зависимости от относительных напряжений электродов истока и стока. Источником является более отрицательная сторона для N-MOS или более положительная сторона для P-MOS. Все эти переключатели ограничены в том, какие сигналы они могут передавать или останавливать, в зависимости от их напряжений затвор-исток, затвор-сток и исток-сток; превышение пределов напряжения, тока или мощности может привести к повреждению переключателя.
В этом аналоговом переключателе используется простой МОП-транзистор с четырьмя выводами типа P или N.
В случае переключателя n-типа корпус подключается к самому отрицательному источнику питания (обычно GND), а затвор используется в качестве управления переключателем. Всякий раз, когда напряжение затвора превышает напряжение истока хотя бы на пороговое напряжение, МОП-транзистор проводит ток. Чем выше напряжение, тем больше может проводить МОП-транзистор. N-МОП-переключатель пропускает все напряжения ниже, чем V затвор – V tn . Когда ключ является проводящим, он обычно работает в линейном (или омическом) режиме работы, поскольку напряжения истока и стока обычно почти равны.
В случае P-MOS корпус подключается к наиболее положительному напряжению, а затвор переводится к более низкому потенциалу, чтобы включить переключатель. Переключатель P-MOS пропускает все напряжения выше, чем V затвор - V tp (пороговое напряжение V tp отрицательно в случае P-MOS режима улучшения).
В этом «дополнительном» или КМОП-переключателе используется один П-МОП-транзистор и один N-МОП-транзистор, чтобы нейтрализовать ограничения однотипного переключателя. У полевых транзисторов стоки и истоки соединены параллельно, корпус P-MOS подключен к высокому потенциалу ( V DD ), а корпус N-MOS подключен к низкому потенциалу ( gnd ). Чтобы включить переключатель, затвор P-MOS переводится в низкий потенциал, а затвор N-MOS — в высокий потенциал. Для напряжений между V DD − V tn и gnd − V tp оба полевых транзистора проводят сигнал; для напряжений ниже gnd − V tp N-МОП проводит ток самостоятельно; а для напряжений, превышающих V DD − V tn , P-MOS проводит ток самостоятельно.
Пределы напряжения для этого переключателя — это пределы напряжения затвор-исток, затвор-сток и исток-сток для обоих полевых транзисторов. Кроме того, P-MOS обычно в два-три раза шире, чем N-MOS, поэтому переключатель будет сбалансирован по скорости в двух направлениях.
Схема с тремя состояниями иногда включает в себя переключатель CMOS MOSFET на своем выходе, чтобы обеспечить низкоомный выходной сигнал полного диапазона при включении и высокоомный сигнал среднего уровня в выключенном состоянии.
Основным критерием выбора материала затвора является то, что он является хорошим проводником . Высоколегированный поликристаллический кремний является приемлемым, но, конечно, не идеальным проводником, а также страдает некоторыми техническими недостатками в качестве стандартного материала затвора. Тем не менее, есть несколько причин в пользу использования поликремния:
Хотя затворы из поликремния были фактическим стандартом в течение последних двадцати лет, у них есть некоторые недостатки, которые привели к их вероятной замене в будущем металлическими затворами. К этим недостаткам относятся:
В современных высокопроизводительных процессорах используется технология металлических затворов вместе с диэлектриками с высоким κ , комбинация, известная как металлические затворы с высоким κ (HKMG). Недостатки металлических ворот преодолеваются несколькими способами: [36]
Поскольку устройства становятся меньше, изолирующие слои становятся тоньше, часто за счет термического окисления или локализованного окисления кремния ( LOCOS ). Для наноустройств в какой-то момент происходит туннелирование носителей через изолятор от канала к электроду затвора. Чтобы уменьшить возникающий ток утечки , изолятор можно сделать тоньше, выбрав материал с более высокой диэлектрической проницаемостью. Чтобы увидеть, как связаны толщина и диэлектрическая проницаемость, обратите внимание, что закон Гаусса связывает поле с зарядом следующим образом:
где Q = плотность заряда, κ = диэлектрическая проницаемость, ε 0 = диэлектрическая проницаемость пустого пространства и E = электрическое поле. Из этого закона следует, что тот же заряд может сохраняться в канале при более низком поле при условии увеличения κ. Напряжение на затворе определяется выражением:
где V G = напряжение затвора, V ch = напряжение на стороне канала изолятора и t ins = толщина изолятора. Это уравнение показывает, что напряжение затвора не будет увеличиваться при увеличении толщины изолятора при условии, что κ увеличивается, чтобы поддерживать t ins / κ = постоянным (более подробную информацию см. В статье о диэлектриках с высоким κ, а также в разделе этой статьи об утечке оксида затвора). ).
Изолятор в МОП-транзисторе представляет собой диэлектрик, который в любом случае может представлять собой оксид кремния, образованный LOCOS , но могут использоваться и многие другие диэлектрические материалы. Общий термин для обозначения диэлектрика — «диэлектрик затвора», поскольку диэлектрик расположен непосредственно под электродом затвора и над каналом полевого МОП-транзистора.
Переходы исток-тело и сток-тело являются объектом большого внимания из-за трех основных факторов: их конструкция влияет на вольт-амперные характеристики ( IV ) устройства, снижая выходное сопротивление, а также скорость устройство за счет нагрузочного эффекта емкостей перехода и , наконец, компонента рассеяния мощности в режиме ожидания из-за утечки перехода.

Снижение порогового напряжения, вызванное стоком, и эффекты модуляции длины канала на ВАХ уменьшаются за счет использования расширений мелкого перехода. Кроме того, можно использовать галолегирование , то есть добавление очень тонких сильнолегированных областей того же типа легирования, что и тело, плотно прилегающих к стенкам перехода, чтобы ограничить степень обеднения областей . [37]
Емкостные эффекты ограничиваются за счет использования приподнятой геометрии истока и стока, в результате которой большая часть границы области контакта становится толстым диэлектриком, а не кремнием. [38]
Эти различные особенности конструкции перекрестка показаны (с художественным разрешением ) на рисунке.
За последние десятилетия размер МОП-транзистора (используемого для цифровой логики) постоянно уменьшался; Типичная длина канала МОП-транзистора когда-то составляла несколько микрометров , но современные интегральные схемы включают МОП-транзисторы с длиной канала в десятки нанометров. Работа Роберта Деннарда по теории масштабирования сыграла решающую роль в признании того, что такое продолжающееся сокращение возможно. Intel начала производство процесса с размером элемента 32 нм (с каналом еще короче) в конце 2009 года. Полупроводниковая промышленность поддерживает «дорожную карту» ITRS [ 39] , которая задает темп развития MOSFET. Исторически трудности с уменьшением размера МОП-транзистора были связаны с процессом изготовления полупроводниковых устройств, необходимостью использования очень низких напряжений и более низкими электрическими характеристиками, что требовало перепроектирования и инноваций схемы (небольшие МОП-транзисторы имеют более высокие токи утечки и более низкое выходное сопротивление). ).
МОП-транзисторы меньшего размера желательны по нескольким причинам. Основная причина уменьшения размеров транзисторов — размещение все большего количества устройств на заданной площади кристалла. В результате получается чип с той же функциональностью на меньшей площади или чипы с большей функциональностью на той же площади. Поскольку затраты на производство полупроводниковой пластины относительно фиксированы, стоимость интегральной схемы в основном связана с количеством микросхем, которые можно произвести на одной пластине. Следовательно, интегральные схемы меньшего размера позволяют использовать больше чипов на пластине, что снижает цену за чип. Фактически, за последние 30 лет количество транзисторов на чип удваивалось каждые 2–3 года после внедрения нового технологического узла. Например, количество МОП-транзисторов в микропроцессоре, изготовленном по технологии 45 нм, вполне может быть в два раза больше, чем в чипе 65 нм . Это удвоение плотности транзисторов было впервые обнаружено Гордоном Муром в 1965 году и обычно называется законом Мура . [40] Также ожидается, что транзисторы меньшего размера переключаются быстрее. Например, одним из подходов к уменьшению размеров является масштабирование МОП-транзистора, требующее пропорционального уменьшения всех размеров устройства. Основными размерами устройства являются длина канала, ширина канала и толщина оксида. При уменьшении их в равных коэффициентах сопротивление канала транзистора не меняется, а емкость затвора уменьшается на этот коэффициент. Следовательно, RC-задержка транзистора масштабируется с аналогичным коэффициентом. Хотя это традиционно имело место для более старых технологий, для современных МОП-транзисторов уменьшение размеров транзистора не обязательно приводит к более высокой скорости кристалла, поскольку задержка из-за межсоединений более значительна.
Производство МОП-транзисторов с длиной канала намного меньше микрометра является сложной задачей, а трудности производства полупроводниковых устройств всегда являются ограничивающим фактором в развитии технологии интегральных схем. Хотя такие процессы, как ALD , позволили улучшить производство небольших компонентов, небольшой размер MOSFET (менее нескольких десятков нанометров) создал эксплуатационные проблемы:
Поскольку геометрия МОП-транзистора уменьшается, напряжение, которое может быть приложено к затвору, должно быть уменьшено для сохранения надежности. Для поддержания производительности необходимо также снизить пороговое напряжение MOSFET. Поскольку пороговое напряжение снижается, транзистор не может переключиться из режима полного закрытия в состояние полного открытия при доступном ограниченном размахе напряжения; конструкция схемы представляет собой компромисс между сильным током во включенном состоянии и низким током в выключенном случае, и приложение определяет, отдать ли предпочтение одному из них. Подпороговая утечка (включая подпороговую проводимость, утечку затвор-оксид и утечку обратно-смещенного перехода), которая игнорировалась в прошлом, теперь может потреблять более половины общего энергопотребления современных высокопроизводительных микросхем СБИС. [41] [42]
Оксид затвора, который служит изолятором между затвором и каналом, должен быть как можно тоньше, чтобы увеличить проводимость и производительность канала, когда транзистор включен, и уменьшить подпороговую утечку, когда транзистор выключен. Однако при использовании нынешних оксидов затвора толщиной около 1,2 нм (что в кремнии составляет ~ 5 атомов ) между затвором и каналом возникает квантовомеханическое явление туннелирования электронов , что приводит к увеличению энергопотребления. Диоксид кремния традиционно использовался в качестве изолятора затвора. Однако диоксид кремния имеет умеренную диэлектрическую проницаемость. Увеличение диэлектрической проницаемости диэлектрика затвора позволяет получить более толстый слой при сохранении высокой емкости (емкость пропорциональна диэлектрической проницаемости и обратно пропорциональна толщине диэлектрика). При прочих равных условиях более высокая толщина диэлектрика уменьшает квантовый туннельный ток через диэлектрик между затвором и каналом.
Изоляторы, которые имеют большую диэлектрическую проницаемость , чем диоксид кремния (называемые диэлектриками с высоким κ ), такие как силикаты металлов группы IVb, например, силикаты и оксиды гафния и циркония , используются для уменьшения утечки затвора, начиная с технологического узла 45 нанометров. С другой стороны, важным фактором является высота барьера нового изолятора затвора; разница в энергии зоны проводимости между полупроводником и диэлектриком (и соответствующая разница в энергии валентной зоны ) также влияет на уровень тока утечки. Для традиционного затворного оксида, диоксида кремния, первый барьер составляет примерно 8 эВ . Для многих альтернативных диэлектриков это значение значительно ниже, что приводит к увеличению туннельного тока, что несколько сводит на нет преимущество более высокой диэлектрической проницаемости. Максимальное напряжение затвор-исток определяется силой электрического поля, которое может поддерживаться диэлектриком затвора до того, как произойдет значительная утечка. Поскольку изолирующий диэлектрик становится тоньше, напряженность электрического поля внутри него увеличивается при фиксированном напряжении. Это требует использования более низких напряжений с более тонким диэлектриком.
Чтобы сделать устройства меньше, конструкция перехода стала более сложной, что привело к более высоким уровням легирования , более мелким переходам, легированию «гало» и т. д., [43] [44] и все это для уменьшения снижения барьера, вызванного стоком (см. раздел о конструкции перехода). ). Чтобы сохранить эти сложные переходы на месте, необходимо сократить этапы отжига, которые раньше использовались для устранения повреждений и электрически активных дефектов [45] , что увеличивает утечку через переход. Более сильное легирование также связано с более тонкими обедненными слоями и большим количеством центров рекомбинации, что приводит к увеличению тока утечки даже без повреждения решетки.
Снижение барьера, вызванное стоком (DIBL) и спад V T : из-за эффекта короткого канала формирование канала не полностью осуществляется затвором, но теперь сток и исток также влияют на формирование канала. По мере уменьшения длины канала области истощения истока и стока сближаются и делают пороговое напряжение ( VT ) функцией длины канала. Это называется спадом V T. V T также становится функцией напряжения стока к истоку V DS . Когда мы увеличиваем VDS , области истощения увеличиваются в размерах, и значительная часть заряда истощается VDS . Напряжение затвора, необходимое для формирования канала, затем снижается, и, таким образом, V T уменьшается с увеличением V DS . Этот эффект называется снижением барьера, вызванным дренажем (DIBL).
Для аналоговой работы хороший коэффициент усиления требует высокого выходного сопротивления МОП-транзистора, то есть ток МОП-транзистора должен незначительно меняться в зависимости от приложенного напряжения сток-исток. Поскольку устройства становятся меньше, влияние стока более успешно конкурирует с влиянием затвора из-за растущей близости этих двух электродов, увеличивая чувствительность тока МОП-транзистора к напряжению стока. Чтобы противодействовать результирующему уменьшению выходного сопротивления, схемы усложняются, либо требуя большего количества устройств, например, каскадных и каскадных усилителей , либо схемы обратной связи с использованием операционных усилителей , например, схемы, подобной той, что показана на соседнем рисунке.
Крутизна МОП-транзистора определяет его коэффициент усиления и пропорциональна подвижности дырок или электронов (в зависимости от типа устройства), по крайней мере, для низких напряжений стока. По мере уменьшения размера МОП-транзистора поля в канале увеличиваются и уровень примесей легирующей примеси увеличивается. Оба изменения уменьшают подвижность носителей и, следовательно, крутизну. Поскольку длина канала уменьшается без пропорционального уменьшения напряжения стока, что приводит к увеличению электрического поля в канале, результатом является насыщение носителей по скорости, ограничивающее ток и крутизну.
Традиционно время переключения было примерно пропорционально емкости затворов. Однако по мере того, как транзисторы становятся все меньше и больше транзисторов размещается на кристалле, емкость межсоединений (емкость соединений металлических слоев между различными частями чипа) становится значительным процентом емкости. [46] [47] Сигналам приходится проходить через межсоединение, что приводит к увеличению задержки и снижению производительности.
Постоянно растущая плотность МОП-транзисторов в интегральной схеме создает проблемы, связанные со значительным локализованным выделением тепла, которое может ухудшить работу схемы. Цепи работают медленнее при высоких температурах, имеют меньшую надежность и более короткий срок службы. Радиаторы и другие устройства и методы охлаждения теперь необходимы для многих интегральных схем, включая микропроцессоры. Силовые МОП-транзисторы подвержены риску температурного разгона . Поскольку их сопротивление в открытом состоянии увеличивается с температурой, если нагрузка представляет собой нагрузку примерно постоянного тока, потери мощности соответственно возрастают, вызывая дополнительное выделение тепла. Когда радиатор не способен поддерживать достаточно низкую температуру, температура перехода может быстро и неконтролируемо повыситься, что приведет к разрушению устройства.
Поскольку полевые МОП-транзисторы становятся меньше, количество атомов в кремнии, которые определяют многие свойства транзистора, становится меньше, в результате чего контроль количества и размещения легирующих примесей становится более неустойчивым. Во время производства чипов случайные изменения процесса влияют на все размеры транзистора: длину, ширину, глубину перехода, толщину оксида и т. д . и составляют большую долю от общего размера транзистора по мере его сжатия. Характеристики транзистора становятся менее определенными, более статистическими. Случайный характер производства означает, что мы не знаем, какой конкретный образец МОП-транзистора на самом деле окажется в конкретном экземпляре схемы. Эта неопределенность вынуждает использовать менее оптимальную конструкцию, поскольку она должна работать с большим количеством возможных компонентов MOSFET. См. вариации процесса , проектирование с учетом технологичности , обеспечение надежности и статистическое управление процессом . [48]
Современные микросхемы моделируются на компьютере с целью получения рабочих схем из самой первой изготовленной партии. Поскольку устройства миниатюризируются, сложность обработки затрудняет точное предсказание того, как будут выглядеть конечные устройства, а моделирование физических процессов также становится более сложной задачей. Кроме того, микроскопические изменения в структуре, обусловленные просто вероятностной природой атомных процессов, требуют статистических (а не только детерминистских) предсказаний. В совокупности эти факторы затрудняют адекватное моделирование и производство «с первого раза».

МОП-транзистор с двумя затворами имеет тетродную конфигурацию, в которой оба затвора контролируют ток в устройстве. Он обычно используется для устройств со слабым сигналом в радиочастотных приложениях, где смещение затвора на стороне стока при постоянном потенциале уменьшает потери усиления, вызванные эффектом Миллера , заменяя два отдельных транзистора в каскодной конфигурации. Другие распространенные применения в радиочастотных схемах включают регулировку усиления и микширование (преобразование частоты). Описание тетрода , хотя и точное, не повторяет тетрод с электронной лампой. Ламповые тетроды, использующие экранирующую сетку, имеют гораздо меньшую емкость сеточной пластины и гораздо более высокий выходной импеданс и коэффициент усиления по напряжению, чем триодные электронные лампы. Эти улучшения обычно составляют порядок величины (в 10 раз) или значительно больше. Тетродные транзисторы (будь то биполярные или полевые) не демонстрируют столь значительных улучшений.
FinFET — это устройство « кремний на изоляторе» с двойным затвором , одна из многих геометрий, введенных для смягчения эффектов коротких каналов и уменьшения снижения барьера, вызванного стоком. Плавник относится к узкому каналу между источником и стоком . Тонкий изолирующий оксидный слой по обе стороны ребра отделяет его от затвора. SOI FinFET с толстым оксидом на верхней части ребра называются двухзатворными , а те, у которых тонкий оксид сверху и по бокам, называются FinFET с тройным затвором . [49] [50]
Существуют МОП -транзисторы с режимом обеднения , которые используются реже, чем уже описанные стандартные устройства с режимом улучшения . Это устройства MOSFET, которые легированы так, что канал существует даже при нулевом напряжении от затвора к истоку. Для управления каналом на затвор подается отрицательное напряжение (для n-канального устройства), обедняющее канал, что уменьшает ток, протекающий через устройство. По сути, устройство режима истощения эквивалентно нормально закрытому (включенному) переключателю, а устройство режима улучшения эквивалентно нормально открытому (выключенному) переключателю. [51]
Из-за низкого коэффициента шума в радиочастотном диапазоне и лучшего усиления эти устройства часто предпочтительнее биполярных устройств в радиочастотных входных каскадах , например, в телевизорах .
Семейства МОП-транзисторов с режимом истощения включают BF960 от Siemens и Telefunken , а также BF980 1980-х годов от Philips (позже ставшего NXP Semiconductors ), чьи производные до сих пор используются во входных каскадах АРУ и радиочастотных смесителях .
Полевой транзистор металл-изолятор-полупроводник, [52] [53] [54] или MISFET , является более общим термином, чем MOSFET , и синонимом полевого транзистора с изолированным затвором (IGFET). Все МОП-транзисторы являются МОП-транзисторами, но не все МОП-транзисторы являются МОП-транзисторами.
Диэлектрическим изолятором затвора в МОП-транзисторе является диоксид кремния , но можно использовать и другие материалы. Диэлектрик затвора расположен непосредственно под электродом затвора и над каналом МДП-транзистора. Термин « металл» исторически использовался для обозначения материала затвора, хотя сейчас это обычно высоколегированный поликремний или какой-либо другой неметалл .
Типы изоляторов могут быть:
Для устройств с одинаковой способностью управления током n-канальные МОП-транзисторы могут быть меньше, чем p-канальные МОП-транзисторы, поскольку p-канальные носители заряда ( дырки ) имеют меньшую подвижность , чем n-канальные носители заряда ( электроны ), и производят только один тип МОП-транзистора на кремниевой подложке дешевле и технически проще. Это были основные принципы разработки NMOS-логики , в которой используются исключительно n-канальные МОП-транзисторы. Однако, если пренебречь током утечки , в отличие от логики CMOS, логика NMOS потребляет мощность, даже когда переключение не происходит. С развитием технологий в середине 1980-х годов логика КМОП вытеснила логику НМОП и стала предпочтительным процессом для цифровых микросхем.

Силовые МОП-транзисторы имеют другую структуру. [56] Как и в большинстве силовых устройств, структура вертикальная, а не плоская. Используя вертикальную структуру, транзистор может выдерживать как высокое запирающее напряжение, так и большой ток. Номинальное напряжение транзистора является функцией легирования и толщины N- эпитаксиального слоя (см. поперечное сечение), а номинальный ток - функцией ширины канала (чем шире канал, тем выше ток). В планарной структуре номинальные ток и напряжение пробоя зависят от размеров канала (соответственно ширины и длины канала), что приводит к неэффективному использованию «кремниевого имущества». При вертикальной структуре площадь компонента примерно пропорциональна току, который он может выдержать, а толщина компонента (фактически толщина N-эпитаксиального слоя) пропорциональна напряжению пробоя. [57]
Мощные МОП-транзисторы с боковой структурой в основном используются в усилителях звука высокого класса и мощных акустических системах. Их преимуществом является лучшее поведение в насыщенной области (соответствующей линейной области биполярного транзистора), чем у вертикальных МОП-транзисторов. Вертикальные МОП-транзисторы предназначены для коммутационных приложений. [58]
Существуют LDMOS (металлооксидный полупроводник с боковой двойной диффузией) и VDMOS (металлооксидный полупроводник с вертикальной двойной диффузией). Большинство силовых МОП-транзисторов изготавливаются по этой технологии.
Полупроводниковые электронные схемы субмикрометрового и нанометрового размера являются основной проблемой для работы в пределах нормального допуска в суровых радиационных средах, таких как космическое пространство . Одним из подходов к созданию радиационно-стойкого устройства (RHBD) является транзистор закрытой компоновки (ELT). Обычно затвор МОП-транзистора окружает сток, который расположен в центре ELT. Исток МОП-транзистора окружает затвор. Другой МОП-транзистор RHBD называется H-Gate. Оба этих транзистора имеют очень низкие токи утечки по отношению к излучению. Однако они большие по размеру и занимают больше места на кристалле, чем стандартный МОП-транзистор. В более старых конструкциях STI (изоляция с неглубокими траншеями) удары радиации вблизи области оксида кремния вызывают инверсию канала в углах стандартного МОП-транзистора из-за накопления захваченных зарядов, индуцированных радиацией. Если заряды достаточно велики, накопленные заряды влияют на края поверхности STI вдоль канала вблизи границы канала (затвора) стандартного МОП-транзистора. Это приводит к инверсии канала устройства по краям канала, создавая путь утечки в выключенном состоянии. После этого устройство включается; этот процесс серьезно снижает надежность цепей. ELT предлагает множество преимуществ, в том числе повышение надежности за счет уменьшения нежелательной инверсии поверхности на краях затвора, которая возникает в стандартных МОП-транзисторах. Поскольку края затвора заключены в ELT, оксидная кромка затвора отсутствует (STI на интерфейсе затвора), и, таким образом, утечка транзистора в закрытом состоянии значительно снижается. Микроэлектронные схемы малой мощности, включая компьютеры, устройства связи и системы мониторинга на космических кораблях и спутниках, сильно отличаются от тех, что используются на Земле. Они представляют собой схемы, устойчивые к радиации (высокоскоростные атомные частицы, такие как протон и нейтрон , рассеивание магнитной энергии солнечных вспышек в земном пространстве, энергичные космические лучи , такие как рентгеновские лучи , гамма-лучи и т. д.). Эта специальная электроника разработана с использованием различных технологий с использованием RHBD MOSFET для обеспечения безопасных космических путешествий и выходов астронавтов в открытый космос.