Память с фазовым изменением (также известная как PCM , PCME , PRAM , PCRAM , OUM ( овоническая унифицированная память ) и C-RAM или CRAM ( халькогенидное ОЗУ )) — это тип энергонезависимой оперативной памяти . PRAM используют уникальное поведение халькогенидного стекла . В ПКМ тепло, вырабатываемое при прохождении электрического тока через нагревательный элемент , обычно изготовленный из нитрида титана, используется либо для быстрого нагрева и закалки стекла, делая его аморфным , либо для удержания его в диапазоне температур кристаллизации в течение некоторого времени, тем самым переводя его в кристаллическое состояние. [1] PCM также обладает способностью достигать ряда различных промежуточных состояний, тем самым имея возможность хранить несколько битов в одной ячейке, [2] но трудности в программировании ячеек таким способом не позволили реализовать эти возможности в другие технологии (особенно флэш-память ) с такими же возможностями.
Недавние исследования PCM были направлены на попытку найти жизнеспособные альтернативы материалу с фазовым переходом Ge 2 Sb 2 Te 5 (GST), но с переменным успехом. Другие исследования были сосредоточены на разработке сверхрешетки Ge Te – Sb 2 Te 3 для достижения нетепловых фазовых изменений путем изменения координационного состояния атомов германия с помощью лазерного импульса. Эта новая межфазная память с изменением фазы (IPCM) имела много успехов и продолжает оставаться местом многих активных исследований. [3]
Леон Чуа утверждал, что все двухполюсные устройства с энергонезависимой памятью , включая PCM, следует считать мемристорами . [4] Стэн Уильямс из HP Labs также утверждал, что PCM следует считать мемристором. [5] Однако эта терминология была оспорена, и потенциальная применимость мемристорной теории к любому физически реализуемому устройству остается под вопросом. [6] [7]
В 1960-х годах Стэнфорд Р. Овшинский из Energy Conversion Devices впервые исследовал свойства халькогенидных стекол как потенциальной технологии памяти. В 1969 году Чарльз Си опубликовал диссертацию в Университете штата Айова , в которой описал и продемонстрировал возможность создания устройства памяти с фазовым изменением путем интеграции халькогенидной пленки с диодной матрицей. [8] [9] Кинематографическое исследование, проведенное в 1970 году, установило, что механизм фазовой памяти в халькогенидном стекле включает рост кристаллических нитей, индуцированный электрическим полем . [10] [11] В сентябрьском номере журнала Electronics за 1970 год Гордон Мур , соучредитель Intel , опубликовал статью об этой технологии. [12] Однако проблемы качества материала и энергопотребления помешали коммерциализации технологии. Совсем недавно интерес и исследования возобновились, поскольку ожидается, что технологии флэш-памяти и DRAM- памяти столкнутся с трудностями масштабирования по мере сжатия литографии чипов . [13]
Кристаллическое и аморфное состояния халькогенидного стекла имеют резко разные значения удельного электросопротивления . Аморфное состояние с высоким сопротивлением представляет собой двоичный 0, а кристаллическое состояние с низким сопротивлением представляет собой 1. Халькогенид — это тот же материал , который используется в перезаписываемых оптических носителях (таких как CD-RW и DVD-RW ). В этих случаях манипулируют оптическими свойствами материала, а не его электрическим сопротивлением, поскольку показатель преломления халькогенида также меняется в зависимости от состояния материала.
Хотя PRAM еще не достигла стадии коммерциализации потребительских электронных устройств, почти во всех прототипах устройств используется халькогенидный сплав германия (Ge), сурьмы (Sb) и теллура (Te), называемый GeSbTe (GST). Стехиометрия , или соотношение элементов Ge:Sb:Te, составляет 2:2:5 в GST. При нагревании GST до высокой температуры (более 600 °C) его халькогенидная кристалличность теряется. После охлаждения он замерзает в аморфное стеклоподобное состояние [14] и имеет высокое электрическое сопротивление . Нагревая халькогенид до температуры выше точки его кристаллизации , но ниже точки плавления , он перейдет в кристаллическое состояние с гораздо меньшим сопротивлением. Время завершения этого фазового перехода зависит от температуры. Кристаллизация более холодных частей халькогенида занимает больше времени, а перегретые части могут быть переплавлены. Обычно используется время кристаллизации порядка 100 нс . [15] Это дольше, чем у обычных устройств энергозависимой памяти, таких как современная DRAM , время переключения которых составляет порядка двух наносекунд. Однако в патентной заявке Samsung Electronics, поданной в январе 2006 года , указывается, что время переключения PRAM может достигать пяти наносекунд.
Достижение, предпринятое в 2008 году компаниями Intel и ST Microelectronics, позволило более тщательно контролировать состояние материала, позволяя преобразовать его в одно из четырех различных состояний: предыдущие аморфные или кристаллические состояния, а также два новых частично кристаллических состояния. Каждое из этих состояний имеет разные электрические свойства, которые можно измерить во время чтения, что позволяет одной ячейке представлять два бита , что удваивает плотность памяти . [16]
Устройства памяти с фазовым переходом на основе германия , сурьмы и теллура создают проблемы при производстве, поскольку травление и полировка материала халькогенами могут изменить его состав. Материалы на основе алюминия и сурьмы более термически стабильны, чем GeSbTe . Al 50 Sb 50 имеет три различных уровня сопротивления, что дает возможность хранить три бита данных в двух ячейках вместо двух (для пары ячеек возможно девять состояний, использование восьми из этих состояний дает log 2 8 = 3 бита). [17] [18]
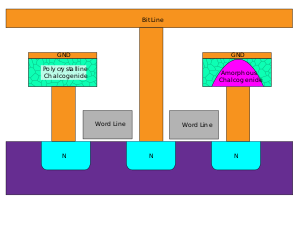
Время переключения PRAM и присущая ей масштабируемость [19] делают ее более привлекательной, чем флэш-память . Температурная чувствительность PRAM, пожалуй, является ее самым заметным недостатком, который может потребовать изменений в производственном процессе производителей, использующих эту технологию.
Флэш-память работает путем модуляции заряда ( электронов ), хранящегося внутри затвора МОП-транзистора . Затвор состоит из специальной «стопки», предназначенной для улавливания зарядов (либо на плавающем затворе, либо в изоляционных «ловушках» ). Наличие заряда внутри затвора сдвигает пороговое напряжение транзистора выше или ниже, что соответствует изменению состояния бита ячейки с 1 на 0 или с 0 на 1. Изменение состояния бита требует удаления накопленного заряда, что требует относительно большого напряжения. «высасывать» электроны из плавающего затвора. Этот всплеск напряжения обеспечивается зарядовым насосом , которому требуется некоторое время для набора мощности. Общее время записи для обычных флэш-устройств составляет порядка 100 мкс (для блока данных), что примерно в 10 000 раз превышает типичное время чтения 10 нс для SRAM , например (для байта ). [ нужна цитата ]
PRAM может обеспечить гораздо более высокую производительность в приложениях, где важна быстрая запись, как потому, что элемент памяти можно переключать быстрее, так и потому, что отдельные биты могут быть изменены на 1 или 0 без необходимости предварительного стирания всего блока ячеек. Высокая производительность PRAM, в тысячи раз превышающая скорость обычных жестких дисков , делает ее особенно интересной для энергонезависимой памяти , производительность которой в настоящее время ограничена временем доступа к памяти.
Кроме того, при использовании вспышки каждый всплеск напряжения на ячейке вызывает деградацию. По мере уменьшения размера ячеек ущерб от программирования увеличивается, поскольку напряжение, необходимое для программирования устройства, не масштабируется с литографией. Большинство флэш-устройств в настоящее время рассчитаны только на 5000 операций записи на сектор, и многие флэш-контроллеры выполняют выравнивание износа для распределения операций записи по множеству физических секторов.
Устройства PRAM также деградируют по мере использования по другим причинам, чем флэш-память, но деградируют гораздо медленнее. Устройство PRAM может выдержать около 100 миллионов циклов записи. [20] Срок службы PRAM ограничен такими механизмами, как деградация из-за теплового расширения GST во время программирования, миграция металла (и других материалов) и другие механизмы, которые до сих пор неизвестны.
Детали флэш-памяти можно запрограммировать перед пайкой на плату или даже приобрести предварительно запрограммированными. Однако содержимое PRAM теряется из-за высоких температур, необходимых для припайки устройства к плате (см. пайку оплавлением или волновую пайку ). Ситуация усугублялась требованием бессвинцового производства, требующего более высоких температур пайки. Производитель, использующий детали PRAM, должен предоставить механизм для программирования PRAM «внутри системы» после ее припайки на место.
Специальные вентили, используемые во флэш-памяти, со временем «утекают» заряд (электроны), вызывая повреждение и потерю данных. Сопротивление элемента памяти в PRAM более стабильно ; Предполагается, что при нормальной рабочей температуре 85 °C данные будут храниться в течение 300 лет. [21]
Тщательно модулируя количество заряда, хранящегося на затворе, флэш-устройства могут хранить несколько (обычно два) бита в каждой физической ячейке. По сути, это удваивает плотность памяти , снижая стоимость. Устройства PRAM изначально хранили только один бит в каждой ячейке, но недавние достижения Intel устранили эту проблему. [ нужна цитата ]
Поскольку флэш-устройства улавливают электроны для хранения информации, они подвержены повреждению данных из-за радиации , что делает их непригодными для многих космических и военных применений. PRAM обладает более высокой устойчивостью к радиации.
В селекторах ячеек PRAM могут использоваться различные устройства: диоды , BJT и MOSFET . Использование диода или BJT обеспечивает наибольший ток для данного размера ячейки. Однако проблемы с использованием диода связаны с паразитными токами в соседних ячейках, а также с более высокими требованиями к напряжению, что приводит к более высокому энергопотреблению. Сопротивление халькогенида обязательно больше, чем сопротивление диода, а это означает, что рабочее напряжение должно значительно превышать 1 В, чтобы гарантировать достаточный ток прямого смещения от диода. Возможно, самым серьезным последствием использования массива с диодным выбором, особенно для больших массивов, является общий ток утечки обратного смещения из невыбранных битовых линий. В матрицах, выбранных на основе транзисторов , только выбранные битовые линии вносят вклад в ток утечки обратного смещения. Разница в токе утечки составляет несколько порядков. Еще одной проблемой при масштабировании ниже 40 нм является влияние дискретных примесей при уменьшении ширины pn-перехода . Селекторы на основе тонких пленок обеспечивают более высокую плотность, используя площадь ячеек менее 4 F 2 за счет укладки слоев памяти горизонтально или вертикально. Часто возможности изоляции уступают использованию транзисторов, если коэффициент включения/выключения селектора недостаточен, что ограничивает возможность работы с очень большими массивами в этой архитектуре. Пороговые переключатели на основе халькогенидов были продемонстрированы как жизнеспособный селектор для массивов PCM высокой плотности [22].
В августе 2004 года компания Nanochip лицензировала технологию PRAM для использования в устройствах хранения данных зондов MEMS (микроэлектромеханические системы). Эти устройства не являются твердотельными . Вместо этого очень маленькая пластинка, покрытая халькогенидом, протаскивается под тысячи или даже миллионы электрических зондов, которые могут считывать и записывать халькогенид. Технология микроперемещения Hewlett-Packard позволяет точно позиционировать пластину с точностью до 3 нм , поэтому плотность записи более 1 Тбит (125 ГБ ) на квадратный дюйм станет возможной, если технология будет усовершенствована. Основная идея состоит в том, чтобы уменьшить количество проводов, необходимых внутри кристалла; вместо того, чтобы подключать каждую ячейку, ячейки размещаются ближе друг к другу и считываются с помощью тока, проходящего через зонды МЭМС, действуя как провода. Этот подход напоминает технологию IBM Millipede .
В сентябре 2006 года Samsung анонсировала прототип устройства емкостью 512 МБ (64 МБ ) с диодными переключателями. [23] Это объявление стало своего рода неожиданностью, особенно оно отличалось довольно высокой плотностью памяти . Прототип имел размер ячейки всего 46,7 нм, что меньше, чем у коммерческих флэш -устройств, доступных в то время. Хотя были доступны флэш-устройства большей емкости (64 ГБ или 8 ГБ только появлялись на рынке), другие технологии, конкурирующие за замену флэш-памяти, в целом предлагали меньшую плотность (большие размеры ячеек). Например, единственные серийные устройства MRAM и FeRAM имеют объем всего 4 МБ. Высокая плотность прототипа PRAM-устройства Samsung предполагала, что оно может стать жизнеспособным конкурентом флэш-памяти, а не ограничиваться нишевой ролью, как другие устройства. PRAM оказалась особенно привлекательной в качестве потенциальной замены флэш-памяти NOR , емкость которой обычно отстает от флэш-устройств NAND . Современные емкости на NAND некоторое время назад перевалили за 512 Мб. Флеш-память NOR имеет плотность, аналогичную прототипу PRAM от Samsung, и уже обеспечивает побитовую адресацию (в отличие от NAND, где доступ к памяти осуществляется в банках по много байтов одновременно).
За заявлением Samsung последовало заявление Intel и STMicroelectronics , которые продемонстрировали свои собственные устройства PRAM на форуме разработчиков Intel 2006 года в октябре. [24] Они показали деталь размером 128 МБ, производство которой началось в исследовательской лаборатории STMicroelectronics в Аграте, Италия. Intel заявила, что устройства были строго проверкой концепции .
PRAM также является многообещающей технологией в военной и аэрокосмической промышленности, где радиационные эффекты делают непрактичным использование стандартных энергонезависимых запоминающих устройств , таких как флэш-память. Устройства PRAM были представлены компанией BAE Systems , называемой C-RAM, с заявленной превосходной устойчивостью к радиации ( радиоустойчивостью ) и устойчивостью к защелкам . Кроме того, BAE заявляет о продолжительности цикла записи 10 8 , что позволит ей стать претендентом на замену PROM и EEPROM в космических системах.
В феврале 2008 года Intel и STMicroelectronics представили первый прототип многоуровневой ( MLC ) матрицы PRAM. Прототип хранил два логических бита в каждой физической ячейке, фактически 256 МБ памяти хранилось в физическом массиве емкостью 128 МБ. Это означает, что вместо двух обычных состояний — полностью аморфного и полностью кристаллического — два дополнительных отдельных промежуточных состояния представляют собой разные степени частичной кристаллизации, что позволяет хранить вдвое больше битов в одной и той же физической области. [16] В июне 2011 года [25] IBM объявила, что они создали стабильную, надежную, многоразрядную память с фазовым переходом, обладающую высокой производительностью и стабильностью. У SK Hynix было соглашение о совместной разработке и технологическое лицензионное соглашение с IBM для разработки технологии многоуровневой PRAM. [26]
Также в феврале 2008 года Intel и STMicroelectronics отправили клиентам прототипы своего первого продукта PRAM. Продукт 90 нм, 128 МБ (16 МБ) назывался Alverstone. [27]
В июне 2009 года Samsung и Numonyx BV объявили о совместной разработке аппаратных продуктов PRAM, ориентированных на рынок. [28]
В апреле 2010 года [29] Numonyx анонсировала линейку 128-Мбитной NOR-совместимой памяти с фазовым переходом Omneo. Samsung объявила о поставке 512 МБ оперативной памяти с фазовым переходом (PRAM) в многочиповом корпусе (MCP) для использования в мобильных телефонах осенью 2010 года.
В декабре 2018 года компания STMicroelectronics представила данные о конструкции и производительности массива ePCM объемом 16 МБ для автомобильного блока управления с полностью обедненным кремнием на изоляторе по технологии 28 нм. [30]
В последнее время наблюдается значительный интерес к применению PCM для вычислений в памяти. [31] Основная идея состоит в том, чтобы выполнять вычислительные задачи, такие как операции умножения матрицы на вектор, в самом массиве памяти, используя возможности аналоговой памяти PCM и законы цепей Кирхгофа . Вычисления в памяти на основе PCM могут быть интересны для таких приложений, как глубокое обучение , которые не требуют очень высокой точности вычислений. [32] В 2021 году IBM опубликовала полноценное вычислительное ядро в памяти на основе многоуровневого PCM, интегрированного в технологический узел CMOS 14 нм . [33]
Самой большой проблемой для памяти с фазовым изменением было требование высокой плотности тока программирования (>10 7 А /см 2 по сравнению с 10 5 ...10 6 А/см 2 для типичного транзистора или диода ). [ нужна цитация ] Контакт между горячей областью фазового перехода и прилегающим диэлектриком является еще одной фундаментальной проблемой. Диэлектрик может начать пропускать ток при более высокой температуре или может потерять адгезию при расширении со скоростью, отличной от скорости материала с фазовым переходом.
Память с фазовым изменением подвержена фундаментальному компромиссу между непреднамеренным и запланированным фазовым изменением. Это связано прежде всего с тем фактом, что фазовый переход является термическим, а не электронным процессом. Температурные условия, обеспечивающие быструю кристаллизацию, не должны быть слишком похожи на условия ожидания, например, комнатная температура, иначе сохранение данных будет невозможно. При правильной энергии активации кристаллизации можно добиться быстрой кристаллизации в условиях программирования и очень медленной кристаллизации в нормальных условиях.
Вероятно, самой большой проблемой для памяти с фазовым изменением является ее долговременное сопротивление и дрейф порогового напряжения . [34] Сопротивление аморфного состояния медленно возрастает по степенному закону (~t 0,1 ). Это серьезно ограничивает возможность многоуровневой работы, поскольку более низкое промежуточное состояние позже будет перепутано с более высоким промежуточным состоянием, а также может поставить под угрозу стандартную двухуровневую работу, если пороговое напряжение превысит расчетное значение.
В апреле 2010 года Numonyx выпустила линейку чипов PRAM для замены флэш-памяти NOR с параллельным и последовательным интерфейсом Omneo емкостью 128 МБ . Хотя флэш-чипы NOR, которые они намеревались заменить, работали в диапазоне -40–85 ° C, чипы PRAM работали в диапазоне 0–70 ° C, что указывает на меньшее рабочее окно по сравнению с флэш-памятью NOR. Вероятно, это связано с использованием высокочувствительных к температуре p-n-переходов для обеспечения высоких токов, необходимых для программирования.
{{cite web}}: Cite использует общий заголовок ( справка )